
 | |
|
|
Главная » Книги и журналы 1 ... 6 7 8 9 10 11 12 ... 24 Дуктивным характером полного реактивного сопрор1вления структуры, составляет для сплавных германиевых диодов примерно 0,2 В. Ясно, что эффекты, связанные с наступлением высокого уровня нн-жекцнн, в первую очередь проявляются в более высокоомной нейтральной области перехода. Эффект высокого уровня инжекции проявляется также и в транзисторах преимущественно благодаря процессам в высокоомной области структуры (в базе) н ведет к изменению свойств базы. Процесды в базе при высоком уровне инжекции. До тех пор, пока в однородной базе имеет место низкий уровень .инжекции, можно считать, что концентрация основных носителей определяется термодинамически равновесным значением во всех точках базы (рис. 6.7). В случае же высотого ур01вня инжекции необходимо учитывать сильную зависимость 1К0нцентрации основных носителей от координаты, как это следует из условия электронейтральности: Nd-Pq{x)-по{х) =0 для базы, Ре{х)~Ыа-пе{х) =0 для эмиттера. В дальнейшем мы будем рассматривать лишь соотношения, относящиеся к области базы как к более высокоомной области, так как в эмиттере условия, харак-терные для высокого уровня инжекции, наступают позже. Для ориентировочного расчета прежде всего пренебрегается рекомбинацией носителей в базе и предполагается наличие линейного закона изменения концентрации носителей с координатой *J [уравнение (2.5)] Р  В дальнейшем рекомбинацию учитывают как явление второго порядка. / dn Решение, относящееся к статическому случаю { ведет к равенству нулю дивергенций токов: ds ds. dx dx (6.13a) что связано с условием непрерывности тока в 1каждои точке базы. Из условия же сохранения электронейтраль- *> Начало отсчета совмещено с координатой х = 1пе~0. ности следует равенство градиентов концентраций ос-, новных и неосновных носителей: dp, dx (6.136) Существование градиента концентрации dnidx свидетельствует о том, что в направлении коллектора протекает диффузионный ток основных носителей - электронов. В результате этого во всех точках базы возникает нарушение равновесия между зарядами, а значит, и электронейтральности. Однако отклонение от равновесного состояния весьма мало, что позволяет говорить о квазиравновесных процессах в базе. Граничные значения для решения даются условиями: х = 0, р{Щ==р, /z(0)-Ad + /?(0); x = W, p{W)Q, n{W)n. (6.14) Неизвестная концентрация дырок p{0)=pi однозначно определяется заданными постоянными токами, поскольку между плотностями токов носителей заряда Sp, Sn и концентрацией дырок р(х) имеет место связь, описываемая диффузионным уравнением p + d dp р р p-n dx Я+Л^о Sp = 0. (6.15) Считая, что результирующий ток электронов в базе Sn равен нулю, с учетом граничных условий (6.14) можно получить решение уравнения (6.15), которое содержит /7(0): 2р{0) +1п Р () + 2 (р (0) - р) Р (0) -V (6.16) Упрощение, связанное с предположением о том, что sn~, удобное, но не необходимое условие. Оно означает, что в базе диффузионный и дрейфовый токи уравновешивают друг друга. Предположение о том, что Sn = 0 (распространенное на всю область базы) допустимо для статического режима работы. Однако на высоких частотах в базе должно изменяться во времени количество носителей заряда, запасенных в каждой локальной области базы, и, следовательно, производные dnjdt, dpjdt, а также dSnjdx, А  dSpJdx не будут равны нулю. Условие Sn=0 в этом-лучае будет уже несправедливым. В результате этого в различных точках базы появляются дополнительные корректирующие электрические поля, превышающие по величине первоначально имевшиеся, причем эти дополнительные поля могут не только снижать ускоряющее действие основного поля на неосновные носители, но и вообще исключить его ускоряющее действие. В особенности неправомерно применение условия 5 =0 для описания частотных характеристик при больших токах эмиттера. Чтобы упростить анализ, уравнение (6.16) приводится к безразмерному виду с учетом следующих обозначений:  /7(0) . (6.17) Здесь принято, что 5п = 0, а компонент дырочного тока Sp определяется полным эмиттерным током (Sp ). Безразмерный параметр tjo определяет отношение граничной концентрации дырок у эмиттера к концентрации доноров в базе при условии, что ток эмиттера чисто диффузионный. С учетом этих обозначений уравнения (6.16) принимают вид 1п(1+та), ==2-,-1п(1+т|) (6.18а) (6.186) На рис. 6.8 показаны графики распределения концентрации дырок в базе при различных уровнях инжекции, построенные и а основе графического решения системы уравнений (6.18). Легко видеть, что как для низкого (Г1<С1, Г11<1), так и для высокого (г1>1, Л^П уровня инжекции распределение концентрации дырок ирнбли/кснно может быть описано выражением (6.19) Из рис. 6.8 отчетливо видно, что концентрация неосновных .носителей у эмиттера при высоком уровне инжекции меньше концентрации, обусловленной наличием в базе только диффузионного тока при том же токе эмиттера, т. е. Tii<T]o. Лишь для низких уровней инжекции (rio<l) Зйа-чейЯя Til и щ примерно равнЬ1, при больших кой- центрациях т)о отношение t]i/iio стремится к 1/2. Уменьшение доли диффузионного тока в общем токе эмиттера при увеличении уровня инжекции связано с появлением в (базе дрейфового тока неосновных носителей, обусловленного возрастанием электрического поля в базе. Появления этого эффекта следует ожидать тем скорее, чем больше пло>тность тока и толщина базы и чем меньше концентрация доноров. Эффект высокого уровня инжекции для транзисторов типа р~п'Р должен возникать раньше, чем для п-р-п транзисторов, что связано с различием коэффициентов диффузии носителей заряда.   Рис. 6.8. Распределение нормированной к Nd концентрации неосновных нос1гтелс11 заряда в базе. Оценим, при каких токах следует учитывать эффект высокого уровня инжекции. Пусть Чо!; при \(:10 мкм, Dp -44 см/с, Nd = см~, =1,6-10~* К получаем соответствующую плотность тока Sj> = 0,7 А/см, а для площади эмиттера Ле=10~з см получаем эмиттсрпьм! ток /е 0,7 мА. Концентрация неосновных носителей у эмиттера, которая действительно будет иметь место в этом режиме (г\\), составляет 80% от Чо- Этот пример показывает, что явления, связанные с высоким уровнем инжекции, необходимо учитывать уже при сравнительно малых токах. Можно рекомендовать как некую условную границу для низкочастотных маломощ'ных бездрейфовых транзисторов величину тока эмиттера порядка 0,5-1 мА. С помощью уравнения (б-.Шб) легко вычислить компонент общего тока - диффузионный ток дырок: 1 + 2T), (6.20) Величина D*p, входящая в это выражение, зависит от концентрации носителей в базе и при увеличении кон- центраций возрастает от Dp до 2Dp, Из этого, однако, не следует делать вывод, что факт удеоения коэффициента диффузии можно отнести и к частотным явлениям (например, считать, что из-за изменения Dp изменяется нормировочная частота /i), так как вышеприведенные раосуждения относятся исключительно к статическому режиму работы транзистора.  Рис. 6.9. Зависимость от нормированной координаты отношения дрейфового компонента плотности тока Sfp к обиден плотности тока через эмиттер (1е1Ле) в различных точках базы при увеличении уровня инжекции.  Рис. 6.10. Зависимость от кор-мированиой координаты величины электрического поля Е, нормированной к UtIW, для различных точек базы с ростом уровня нижекции [урап-нение (6.23) . Нз уравпоний (1.2) и (6.20) можно получить выражение для дрейфового компонента дырочного тока: Fp = qpp-pE р dp qlpDn n dx 1 +27J (6.21) Отношение же дрейфового компонента току равно (рис. 6.9) тока к общему 1+2-0 (6.22) Это отношение уменьшается по мере перемещения текущей координаты в базе от эмиттера к коллектору; при высоком уровне инжекции дрейфовый компонент тока может составлять максимум половину общего тока. Вблизи коллеетора дрейфовый ток исчезает независимо от уровня инжекции, так как p{W)Q. Само же элек-тричаакое поле, определяемое соотношением grad9 и т df\ \+У1 dx ~W 1 +27) (6.23) имеет наибольшее значение у коллектора (рис. 6.10); оно возрастаете ростом уровня инжекции. Вблизи коллектора фактор поля EWjUp может достигнуть значительной величины, в остальной же области базы его величина меньше тех значений, которые характерны для дрейфового транзистора. Электрическое поле в базе, возникающее при высоком уровне инжекции, влияет на ток дырок, движущихся от эмиттера к коллектору, аналогично тому, как это имеет место в дрейфовом транзисторе. Однако между инжекциониым полем и встроенным полем дрейфового транзистора имеется существешше различие. В дрейфовом транзисторе электрическое поле возникает вследствие неоднородного распределения концентрации примеси в базе, что приводит к неоднородному распределению концентрации основных носителей. Градиент концентрации этих носителей обусловливает появление диффузионного компонента тока, практически полностью компенси-рую1цего дрейфовый компонент тока основных носителей, подобно тому, как это имеет место в запирающем слое р-п перехода, поскольку, как ясно из граничных условий, в базе может протекать лишь очень малый ток основных носителей. С другой стороны, возникшее поле неизбежно оказывает существенное влияние на ток неосновных носителей, однако сам этот ток ие оказывает обратного воздействия на электрическое поле, так как концентрация основных носителей (при низком уровне инжекции) значительно больше, чем концентрация неосновных носителей. При высоком уровне инжекции электрическое поле в базе (и компенсирующий дрейфовый ток) также возникает вследствие неоднородного распределения концентрации основных носителей, однако причиной изменения концентрации основных носителей является сильная инжекция неосновных носителей заряда. Поэтому как количество инжектированных носителей, так и изменение их распределения во времени оказывают влияние на электрическое поле в базе. Поэтому попытки описать динамические свойства бездрейфового транзистора при высоком., уровне инжекции при помощи формул, выведенных для дрейфового транзистора в режиме низкого уровня инжекции, не привели к желаемому успеху. Высокий уровень инжекции наступает также и в базе дрейфового транзистора, причем возникающее в этом режиме электрическое инжекционное иоле сн15жает эффективность действия первоначально имевшегося поля, что приводит к ухудшению некоторых свойств дрейфового транзистора. Следствием появления электрического поля при высоком уровне инжекции является также и то, что база уже не будет обладать ПОСТОЯННЫМ во всех точках потенциалом, даже при пренебрежении токрм базы. К тому же электрическое поле само по себе неоднородно: оно увеличивается в направлении коллектора (по крайней мере при условии р(\Г)лйО, соответствующем нормальному активному режиму работы, которое до сих пор принималось бесспорным). Эти соображения позволяют рассчитать разность потенциалов между двумя крайними точками базы (Xi = /ne=0, ;с2=/пс=И7):  Uue = У (/ с) - ¥ {Ine) =-\е (x) dx, (6.24) О которая появляется при наличии поля в базе. Одновременно при этом становится неясным, к какой области структуры фактически прикладывается напряженке Ug,Q, и какая часть при.тоженного к эмиттеру напряжения добавляется к напряжению в базе и где, собственно, выбрать точку В'. Точное разъяснение этих вопросов возможно, если рассмотреть определенную геометрию структуры с учетом многомерного характера распределения носителей заряда. Можно провести сравнительные оценки для двух предельных случаев исходя из одномерной модели. В первом случае принимается, что внутренняя точка базы В' находится у границы с эмиттер-ным переходом (т. е. Xilm), во втором - принимается, что точка В' находится в базе у границы с коллектором (т. е. x-lnr). эти случая дают различные граничные неосновных носителей у эмиттера; Оба условия для KOiHUHTрации С л у ч а й 1 - е Случай 2 (1 +.)  е (Г>.25) где ии Upj. соотнетст!5епно напряжение между эмнтте})ом (Е) и граничными плоскостя.\и1 базы х, и х2- Какой из этих двух случаев соответствует действительности, зависит преимуществсшю от геометрии и конструктивного исиолие-иия структуры транзистора. Случай 1, по-видимому, может быть отнесен к тем дрейфовыл! транзисторам, которые имеют мсза-структуру, и вообще к тем плоскостным транзисторам, у которых электрод базы находится на пластинке со стороны эмиттера; случай 2 может быть отнесен к тем транзисторам, у которых базовый электрод находится на пластинке со стороны Коллектора. Разность потенциалов в базе равна гЬ(1 + -о,)->:яБ'>1 (6.26) Следовательно, для обоих указанных случаев будут получаться различные результаты прежде всего для тех параметров, которые непосредственно определяются напряже1ием э.миттер - база (напри- м^р, tif)aMetpH / 6 ypaiftHeHHH (3.7) *i и сбяаашые с нйМи элементы эквивалентных схем замещения). Соотношение между граничной концентрацией дырок р (0) и напряжением f/, необходимое для -расчета вольтамперных характеристик, может быть получено с помощью закона действующих масс** описывающего взаимосвязь между концентрацией основных и неосновных носителей:  р(0)[Л^. + р(0)] £(0)1Л^л + я(0)] = /г е 1 (6.27) или в приведенной форме Ро Jebit (6.28) Уравнение, связывающее концентрацию дырок р и напряжение Up,nn В общем виде весьма гpoюздкce:  4jr?o ebit (6.29) Однако оно упрощается для случая низкого уровня инжекции 4ро ebit  Пх - По Ро ,П'В'1Т е (6.30) и высокого уровня инжекции (-у-е 4/?о УпВ'1т 1 N  Л P.fliQ (6.31) Уравнение (6.31) может создать неправильное впечатление, что якобы на эмиттерном переходе падает только половина напряжения Uj , (в действительности половиной напряжения управляется лишь концентрация pi), и вольтамперная характеристика возрастает медленнее, чем при низком уровне инжекции. *) В первом приближении для малосигиальных дифференциальных параметров данный анализ применим, но в области лишь очень низких частот. **) Строго говоря, закон действующих масс справедлив для термодинамического равновесия. Здесь автор использует лишь формальное соотношение, подобное закону действующих масс в неравновесных условиях. - Прим. перев, ... t Решейие, otнocйщeecя -К ctatHqecKOMy случаю; можйо использовать и для характеристики частотных зависимостей, если переменный сигнал имеет малую амплитуду, а частота его низкая. В Зтом случае полные проводимости внутреннего транзистора [уравнение (3.26)] имеют только действительные составляющие. Реж'им вышкого уровня инжекции при наличии переменного сигнала малой амплитуды отличается лишь тем, что через транзистор протекают большие токи. Полная теория транзистора, работающего в режиме высокого уровня инжекции при приложении переменного сигнала высокой частоты, весьма сложна и имеет ряд пробелов, что становится ясным уже из исследований аналогичных свойств р-п перехода. Явления, связанные с высоким уровнем инжекции, возникают также и в базе с неоднородным распределением примесей. При проведении расчетов для данного случая в отличие от расчетов, проводимых для бездрейфового транзистора, следует учесть зависимость концентрации доноров от координаты, определяющую величину электрического поля: и N [х) + р (х) dx [No {Х) + Р{Х) (6.32) В результате проведения опускаемых здесь подробных расчетов получаем дифференциальное уравнение Л'о (X) + р dp dx Р p (x) p dx Sp = 0. (6.33) Решение этого уравнения можно провести для случая низкого и высокого уровня инжекции. Для получения окончательных выражений воспользуемся граничными условиями: ;с = 0: р(0)=:рь Nu{Q)=Nbo\ (6.34а) x=W: p{W)Q, ND{W)=Nnw-Nnoe-rn причем закон изменения концентрации доноров в базе принят экспоненциальным: (xlW) 2т (6.346) - -: - i f - - Решение для низкого уровня ийжекции было поЛу1{ейо раньше [см. уравнение (4.12)], шриближенное же решение для высокого уровня инжекции имеет вид 1 qDpN -2m (jc/w) (6.35) Ha рис. 6.11 показаны графики распределения концентрации неосновных носителей в базе при большом дрейфовом поле для нескольких случаев различного уровня инжекции. Обращает на себя внимание факт Рис. 6.11. Распределение коицеитрации неосновных носителей р(х), нормировапион к SpWjdDju в базовой области дрейфового транзистора, имеющего сильное встроенное электрическое поле (т = 4), прн различных уровнях инжекции.  наличия максимума па кривой распределения, который сдвигается в сторону эмиттера по мере роста уровня инжекции и наконец совершенно исчезает. При этом распределение концентрации дырок приближается к виду, описываемому линейным законом Р(0) / (6.36) что характерно для бездрейфового транзистора. Таким образом, первоначально имевшееся встроенное электрическое поле уже не играет никакой роли; Заметим, однако, что на основании результатов, полученных для статического случая, нельзя сделать безусловный вывод о том, что при высоком уровне инжекции динамические свойства транзистора ухудшаются. Эффективность эмиттера. Коэффициент переноса. Влияние уровня инжекции сказывается на величине ста- ttiqeckoro коэффициента инжекции (эффективности эмнt-тера) или на величине разности таким образом, как будто проводимость базы хв модулируется при увеличении инжекционното тока. Связь между проводимостью и концентрацией инжектированных носителей устанавливается формулой Молла и Росса для поверхностной проводимости. С учетом распределения концентрации основных носителей По[х) =Nd-{~Po(x) можно рассчитать среднюю проводимость базы [уравнение (5.2)]: в (х) dx и  Y,) dx, (6.37) где хбо - пронодимость базы при малом уровне инжекции. Поскольку необходимая для расчета интеграла зависимость х\[х) в общем виде не известна, то принимают довольно хорошее приближение, огшсываемое уравнением (6.19), и для модулированной проводимости базы получают выражение В (6.38) Отношение г]\/г\о при малых токах имеет величину, равную 1, а при больших токах падает до 1/2 (рис. 6.8); связанный со вторым слагаемым в (6.38) прирост проводимости базы с ростом тока эмиттера ведет к падению коэффициента инжекции и коэффициента передачи тока An- Однако за счет применения сильно легированных слоев эмиттера (у.е велико) абсолютное влияние модуляции проводимости базы па Уе и /Ijv можно снизить. В практике создания сплавных эмиттеров при вплавлении индия в германий величина Хе ограничивалась предельной растворимостью индия в германии. Для повышения хв начали использовать сплав индий - галлий, а в мощных транзисторах- применять также сплав галлий-индий - алюминий, достигая при этом концентрации примеси в эмиттере, на порядок большей, чем в обычных сплавных переходах. Несколько лучше с этой точки зрения обстоит дело в кремниевых дрейфовых транзисторах, в которых эмиттер образуется за счет диффузии фосфора. В таких тран- зистк^ах Bii&uwa получатся кйк ш бШ>шео6 1с^в1фдц^ прнмеси в эмкттерё -10** cм- так н за счет малой толщины базы. Точные расчеты показывают, что с ростом уровня инжекции изменяется также и коэффициент переноса Ан\ уравнен,ие (6.1)], причем за счет из1менения долей объ- емной и поверхностной рекомбинации. Отношение тока поверхностной рекомбинации /нр К общему току неосновных носителей 1ер Для диффузионных транзисторов определяется соотношением  (6.39) где Lu - эффективная длина периметра эмиттерного перехода. Отсюда видно, что с увеличением тока эмиттера отношение IroIIev уменьшается, что должно приводить к росту коэффициента переноса. Приближенный расчет доли объемной рекомбинации при высоком уровне инжекции связан с интегрированием выражения для скорости рекомбинации R и приводит к приближенному выражению о R{x) dx, (6.40) где Ibv - ток базы, обусловленный только объемной рекомбинацией. В случае, когда скорость рекомбинации представляется в виде R={p-ро)/тр, а уровень инжекции низок, из (6.40) следует уравнение (3.11). При высоком уровне инжекции при условии, что процесс рекомбинации характеризуется постоянным средним временем жизни, т. е. р(х) р(0) расчет дает соотношение* А 7]о20рГр (6.41) которое также свидетельствует о росте коэффициента переноса за счет снижения доли объемной рекомбина- Прн более точном анализе в формуле (6.41) вместо коэффициента t]i/t]o появляется коэффициент (\-\-i\\)l{\-\-2-x\\). т 1-1 - ции. Предположение ч) постоянстве времени жизни неосновных носителей и коэффициента диффуаии является идеализадией. В действительности как для германия, так и для кремния Хр зависит от уровня инжекции. Однако до сих пор нет установ1Ившегася мнения о характере влияния изменения тр на объемную рекомбинацию. Некоторые авторы полагают, что Гр увеличивается, что приводит к еще большему снижению доли объемной реком'бинац'ии, другие авторы считают, что Тр уменьшается, что должно приводить к увеличению доли объемной рекомбинации. Коэффициент передачи тока. В статическом случае коэффициент передачи тока определяется эффективностью эмиттера, коэффициентом переноса, учитывающим только объемную рекомбинацию в базе, а также множителем, учитывающим поверхпостпую рекомбинацию:   (6.42) Рост л л- при малых токах эмиттера обеспечивается в основном возрастанием слагаемых, учитывающих потери па рекомбинацию, в то время как уменьшение при больших токах эмиттера связано с уменьшением коэффициента инлчекцни. Максимум кривой в транзисторах с эмиттером, легиро- ванным галлием, весьма резкий, в транзисторах же с эмиттером, легированным алюминием, максимум размыт. Обычно максимум соответствует току эмиттера /е, при котором p - Nv как для германиевых, так и для кремниевых транзисторов, причем положение максимума не зависит от концентрации примеси. Кривая Лл(/е) с максимумом наблюдается также и для дрейфовых транзисторов. В этом случае спад Л л при больших токах более пологий. В меза-транзисторах максимум кривой Л^у (Z) лежит при токах, на 1-2 порядка больших тех токов, которые соответствуют максимуму кривой Ам{!е) для спланных транзисторов. Вышеназ(ваиные причины не исчерпывают всех причин, влияющих на зависимость An от тока эмиттера. Зависимость An(Ie) может быть существенно изменена за счет эффектов оттеснения тока к краю эмиттера (см. § 6.4), рекомбинации носителей в запирающем слое эмиттера, а также упомянутого уже эффекта зависимостн времени жизни носителей от уровня инжекции. Даже геометрия поверхности и глубина проникновения эмиттера (в связи с поверхностной рекомбинацией) важны для получения высоких значений Лдг. MttKC 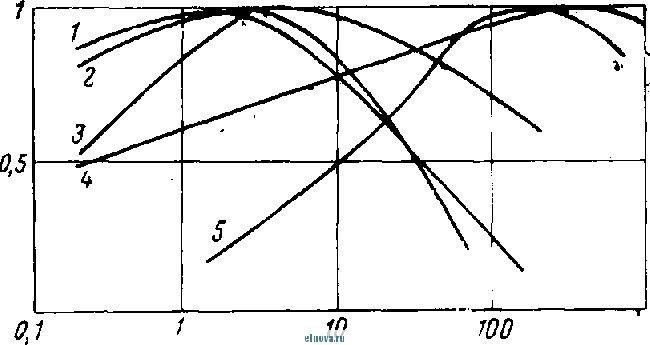 S, А/см Рис. 6.12. Зависимость приведенного статического коэффициента усиления но току В г; от плотности тока коллектора для различных транзисторов: /) р-П'Р (ge) с эмиттером, легированным галлием, Maicc *- p-rj-p (ge) с эмиттером, легированным алюминием, вnjai;c п-р-п (Si) - сплав- n макс iV м а 1; с ной, b,v 35; 4) п-р-п (si) - меза, jvMaKci Р- (si) - планар- Вследствие-того что А^ однозначно определяет - коэффициент усиления по току транзистора в схеме с общим эмиттером: В А в А (6.43) для величины Bn наблюдается аналогичная зависимость от /с. Некоторые типичные зависимости показаны па рис. 6.12, откуда отчетливо видна разница между транзисторами с эмиттерами, легированными галлием и алюминием. Коэффициенты An и Bjv исторически были первыми величинами, которым уделялось большое внимание вследствие того, что они имеют зависимость от тока эмиттера в широком диапазоне его изменения. 6.4. Эффект оттеснения тока к краю эмиттера Одним из неприятных явлений, сопровождающих эффект высокого уровня инжекции, является оттеснение тока инжектированных неосновных носителей к краю эмиттера. Это явление имеет весьма опасные последствия, поскольку может вывести транзистор из строя. Заключается оно в следующем. По мере роста токов в транзисторе базовый ток растет быстрее, чем ток эмиттера, поскольку Лдг надает с ростом /j-:, и вследст-  С  TZZZZZZZZZZZZZ  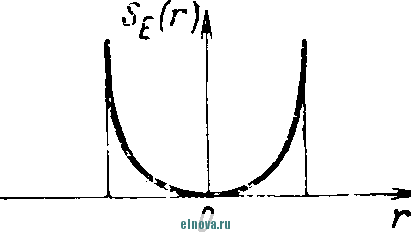 Рис. 6 13. Оттеснение нижектнро-нанных носнтслен заряда к краю ..MHTiejia: а) моде,к. /р.ошистора. па ктором по-:-;к;аип iij.MenGinio с коорднпакл! напряжения на заннракацом слое эмит-горнчго перехода; и) расггределснио плотности тока п Г1Л0СК0СТИ эмиттерного перехода. вне этого возрастает падение напряжения в базе, обусловленное протеканием радиально направленного дрейфового электронного тока базы (в конструкциях транзисторов с кольцевой оазои) (рис. 6.13). Дрейфовое электрическое ноле, иапра13лснное радиально от центральной оси структуры, оттесняет ток неосновных носителей, движущихся к коллектору в направлении к внешнему краю эмиттера. В этих областях плотность тока повышается. При очень высоких плотностях тока инжектирует носители практически только наружная кольцевая область эмиттера с некоей эффективной площадью эмиттера , значительно меньшей, чем действительная площадь эмиттера. Возникает как бы самозапирание внутренней области эмиттера. Согласно анализу, п^оведейибмУ Флетчером, эффект оттеснения становится более заметным с увеличением плотности тока, уменьшением степени легироваиия и толщины базы и уменьшением коэффициента передачи тока. Вследствие эффекта оттеснения в области повышенных плотностей токов высокий уровень инжекции наступает раньше. Эмиттерные кольцо  Базовые кольцо Исходмьш материал (подложка] Рис. 6Л4. Различные виды электродов транзисторных структур, предназначенных для создания приборов на большие мощности рассеяния, R которых ослаблен эффект оттеснения тока: а) кольцевая структура; б) гребенчатая структура. Чтобы ослабить эффект опеспеиии, необходимо при задан поп общей поверхности -.\nniepc; получи п> как можно бб.тьшую площадь эмиттирующей ооласти и как можио меньшее расстояние or э.М1ггтсра лх) :л.кп)о:1:1 базы. Эти условия можно выполнить, созда1зая специальные структуры транзисторов: Г10лос;;овые, кольцезые (в которых концентрические кольца -JMiiTTopa п базы чередуются между собой) и для режимов работы при очень больших токах - гребенчатые (рис. 6Л4). Эффект оттеснения сопровождается целым рядом других допо.1-нительных эффектов: 1. Усиление .поверхностной рекомбинации, пр[1вс)дян1ее к уменьшению коэффициента переноса. При уснлении г^ффекча оттеснения увеличивается ток носителе ii, движущихся но пппрапленню к поверхности, так как линии тока пытссятотся к H;!rjy>k!i!.iM областям эмиттера. В этом случае падение коэффициентов передачи тока .Y. Ai при больших токах должно рассматриваться в связи с эффектом оттеснения. 2. Увеличение в 1,5-3 раза диффузионной емкости эмиттера по сравнению со значением, следующим из одномерной модели транзистора. Меры борьбы с этим явлением связаны с выбором площади коллектора, большей, чем площадь эмиттера {Ас>Ак), 3. Снижение (частичное) граничных частот при высоких плотностях токов. Это явление, в свою очередь, приводит к усилению эффекта оттеснения, так как носители заряда должны проходить больший диффузионный путь от края эмиттера к краю коллектора. V- - - - It 4. Внутренняя тепловая нестабильность, обусловленная неоднородным распределением плотности выделяющейся мощности и, значит, неоднородным распределением температуры в плоскости коллекторного перехода, особенно в транзисторах с большой рабочей поверхностью или в структурах, состоящих нз параллельного соединения многих отдельных структур, сильно связанных между собой в тепловом отношении. По мере роста частоты сигнала базовый ток возрастает, и, следовательно, усиливается тенденция к оттеснению тока и в условиях протекания переменного тока, даже при малых постоянных токах базы. Анализ процессов в двухмерной модели показывает, что для силовых транзисторов процессы в базе могут быть охарактеризованы с помощью комплексного, падающего с ростом частоты сопротивления базы, причем во входной цепи транзистора могут возникнуть даже резонансные явления. 6. 5. Электрический прокол в транзисторе Как было показано (§ 1.1), ширина запирающего слоя зависит от приложенного напряжения, причем при увеличении запирающего напряжения область объемного заряда распространяется преимущественно в более выссч<оомную часть. Так, в транзисторе коллекторныГ] переход расширяется в основном в область базы. При дальнейшем повышении запирающего папряжсння и а коллекторе область объемного заряда продолжаег расти, проникая все глубже в область базы, пока, наконец, области объемного заряда эмиттера и коллектора пе сомкнутся. Транзистор оказывается как бы проколо->1М - исчезает область базы; соответствующее напря- - г женне иа коллекторе называется напряжением прокола (Upt) (punch -through voltage). Если воснользопаться графиком распределения концентрации неосновных носителей в базе (рис. 5.5), то легко объяснить суть явлснип, пpoнcxoдяuui при возрастании обратного смещения. При постоянном напряжении UeB-> градиент концентрации носителей с ростом обратного напряжения на коллекторе становится все больше, так что коллекторный ток растет те.м быстрее, чем дальше проникает запирающий слой коллектора в базу. Если же в эмиттере ток не протекает (холостой ход), то на эмиттере при приложении запирающего напряжения к коллектору появляется отрицательное напряжение - плавающий потенциал UeBF [уравнение (2.216)], так как концентрация неосновных носителей на границе эмиттер - база лежит ниже термодинамически равновесного значения. Повышение коллекторного запирающего напряжения приводит к сужению базы и, следовательно, к уменьшению напряжения 1 пока, наконец, при проколе напряжения с'в'Е'в* становятся линейно зависимыми. Величина капфйжейиЯ ирокола Vpt зависит 6t кой-центрации примесей вблизи переходов, а та-кже от профиля распределения концентрации примеси в базе. Для резкого несимметричного коллекторного перехода напряжение прокола определяется соотношением и о (6.44) где Wq-минимальная технологическая толщина базьь Напряжение прокола характеризует состояние базовой области - ее легирование и плосшнараллельность запцрающих слоев. Это напряжение слабо зависит от состояния поверхности и вообще не зависит от схемы включения. Оно очень чувствительно к наличию в базе участков с шириной, меньшей, чем средняя ширина базы W, и очень слабо зависит от температуры, поскольку По = Мв (const). Напряжение прокола имеет сравнительно большую величину, если по крайней мере хотя бы часть базы слабо легирована. И а пряжение прокола сплавных германиевых низкочастотных транзисторов колеблется между значениями 5 и 50 В, причем транзисторы со сплавным эмиттером и коллектором или диффузионным эмиттером и коллектором имеют напряжение прокола меньше, чем Upt у сплавно-диффузионны.х транзисторов. Особенно чувствительны к эффекту прокола транзисторы с тонкой базой (германиевые высокочастотные транзисторы), которые часто имеют напряжение прокола только порядка 10 В. Для кремниевых транзисторов условия получения больших Upt более благоприятные, если учесть,J4T0 кремний имеет меньшую величину в и подвижность основных носителей. Однако следует заметить, что поскольку в кремнии и коэффициент диффузии неосновных носителей меньше, то для получения больших характеристических частот /i требуется создавать малую толщину базы, что приводит к снижению напряжения прокола. Дрейфовые транзисторы и, прежде всего, транзисторы с высокоомным эпитаксиальным слоем (в том числе и меза-транзисторы) с концентрацией носителей в базе, увеличивающейся по направлению к эмиттеру, имеют большие напряжения прокола, так как изменение ширины запирающего слоя происходит в основном в зоне коллектора. В таких транзисторах возникает новый эф- y.--V* . фш-=-файШШеМе йОсйтёлей в коллективе* кбтоый может привести к резкому возрастанию тока при напряжении, превышающем определенное критическое значение. Однако и для планарных кремниевых /г-р-п транзисторов (наблюдались участки на вольтамперных характеристиках, свидетельствующие об уменьшении сопротивления коллектора при }словиях, при которых может проявляться только эффект прокола. Эффект прокола является обратимым процессом, если имеется достаточное отраничение тока; в это!М случае прокол не приводит к разрушению транзистора. 6.6. Эффект усиления тока в коллекторе В то -время как эффект прокола связан с процессами, процсходящими внутри базовой области, увеличение электрического поля непосредственно в запирающем слое коллектора приводит к эффектам размножения носителей (см. § 1.5), которые могут быть (и часто ими и являются) причинами развития пробоя. При этом речь Нейтральная Запирающий слой область коллектора оллектора 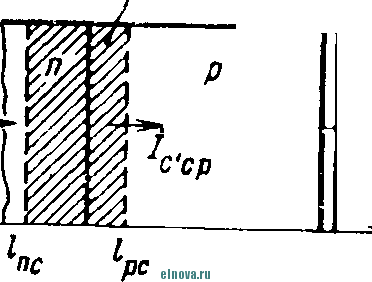 1=1 *1 с с'ср с'сп Рис. 6,15. Схема протекп-пия токов в коллекторной области для поясиеиия эффектов усиления тока в коллекторе. I X идет как об умножении числа носителей как в запирающем слое, так и об усилении тока в нейтральной области коллектора. Оба процесса невозможно отделить друг от друга. Ниже приводится полуколичественное их рассмотрение (рис. 6.15). Переменный ток дырок, достигающих запирающего слоя коллектора, равен 1,. Эти дырки рождают в запирающем слое вследствие размножения новые пары носителей заряда. Поэтому на выходе коллекторного запирающего слоя а = /рс появляется ток большей величины с'ср который вследствие конечного времени пробега носителей через запирающий слой несколько запаздывает 198 г^СгнотенйК) к току Ток 1, втекает в нейтральную область коллектора, внутри которой происходят явления, подобные имеющим место в эмиттере (эффективность эмиттера!). А именно, при наличии относительно высокоомного материала кол- лектора вследствие протекания тока 1, возникает определенное, хотя и слабое, электрическое поле, которое, в свою очередь, приводит к появлению дополнительного дрейфового тока электронов 1,, Поэтому протекающий -Lcn больше, через границу х = 1 общий ток / Сер вытекающий из запирающего слоя коллек- чем ток /, , тора. Процесс усиления тока вследствие обоих эффектов может быть описан с помощью следующих коэффициентов: М с р и /с (6.45) собственный коэффициент усиления коллектора, М (6.46а) коэффициент умножения в запирающем слое коллек- а ССр (6.466) - эффективность коллектора. На практике важнейшими случаями являются режимы работы транзистора либо при таких низких частотах, что запаздывания тока за счет размножения носителей в запирающем слое коллектора несущественны, либо при таких напряжениях на коллекторе, когда электрическое поле в запирающем слое медо, так что размножением носителей можно пренебречь, но следует учитывать время пробега носителей через запирающий слой коллектора (малые напряжения, высокие частоты). В первом случае оба коэффициента Л4 и а* становятся действи- тельными (а* обозначается при этом Л), а 7W совпадает о вышеприведенньш [уравнение (1.93)] коэффициентом 1 ... 6 7 8 9 10 11 12 ... 24 |