
 | |
|
|
Главная » Книги и журналы 1 ... 5 6 7 8 9 10 11 ... 24 tpaльнoй области xc нельйй, поскольку бдноврекеййо увеличивается зарядная емкость коллектора. Нижняя граница хс определяется не столько Гс,с, сколько максимально допустимым коллекторным током, т. е. фактически величиной предельно допустимой мощности потерь в коллекторе. С другой стороны, высокая проводимость коллектора привела бы к малым значениям его пробивного напряжения. Этих трудностей можно избежать если создать структуру с очень узким высокоомным эпитаксиальным слоем вблизи коллекторного перехода. Этот эпитаксиальный слой выращивается на низкоомной подложке, образующей тело коллектора, что ведет в результате к уменьшению сопротивления ГсС  В Рпс. 5.2. Липни тока в базе р-п-р транзистора. 06ii;ee сопротивление базы Г/ складывается из сопротивления актипной базы (rj) и пассивной базы (rg). О - место рекомбинации; - - дырочный ток; ----электронный ток. Сопротивлепне базы гь требует большего внимания, поскольку в данном случае речь идет, строго говоря, о распределенном сопротивлении. Рекомбинация неосновных носителей в относительно высокоомной области базы требует притока основных носителей из базового электрода (рис. 2.6). Рекомбинация пар электрон - дырка происходит беспорядочно во всей области базы (рис. 5.2), в том числе и непосредственно вблизи эмиттерного запирающего слоя. Как следствие глубокого проникновения в базу линий тока, потенциал базы, который раньше принимался постоянным, становится зависящим от координаты. Поэтому напряжение на запирающем слое эмиттера и^в' принимает в различных точках различные значения, например, в точке Pi, расположенной ближе к внешнему базовому контакту, напряжение на переходе будет больше, чем иапряженд1е в точке Рг. Следовательно, к краям эмиттерного запирающего слоя плотность эмиттерного тока возрастает. По мере приближения к базовому электроду ход линий тока постепенно гомогенизируется, так как в этих областях базы не происходит рекомбинации. Общее базовое сопротивление можно представить себе состоящим из двух частей: Гы и Гь2- В то время как составляющая сопротивления базы Гь2 может рассматриваться как линейное активное сопротивление, сопротивление Гы сильно зависит от механизма рекомбинации и распределения тока в базовой области и, таким образом, от режима работы транзистора. Можно провести приближенный количественный расчет процессов в базе, если представить базовую область в виде узких полос (ряд элементарных внутренних транзисторов), в каждой из которых протекает соответствующий ток неосновных носителей. Предполагая, что в базе каждого из элементарных транзисторов плотность тока основных носителей постоянна, можно ввести для каждого нз них индивидуалыюе сопротивлепне базы Параметры каждого из элементарных транзисторов зависят от соответствующего напряжения на запирающем слое, площади инжектирующей поверхности, частоты и распределения тока основных носителей, определяющего в конечном итоге величину соответствующего сопротивления г^. Эти элементарные транзисторы, включая базовое сопротивление г^, образуют систему параллельно соединенных устройств, которая при подключепии сопротивления базы Гь2 моделирует общий транзистор. Отсюда легко видеть, что сопротивление базы, которое до сих пор принималось равным сумме Гь = гы + гь2, также может зависеть от частоты. Зарядную емкость переходов нельзя уже включить в элементарную схему транзистора таким простым способом, как показано на рис. 5.1. Эти емкости следует разложить на отдельные элементарные емкости, которые зависят от напряжения, падающего на соответствующем участке запирающего слоя эмиттера или коллектора. Уже из этих кратких объяснений становится ясной практическая непригодность подобной схемы замещения ш-за трудностей точного расчета величины отдельных её элементов. Несмотря на возникающие трудности, проводят расчет модели транзистора (рис. 5.1) ив случае необходимости вводят соответствующую коррекцию. Из соображений наглядности и простоты практического применения обычно ограничиваются исследованием модели транзистора с услоБной внутренней точкой базы. Если же к точности расчетов предъявляются более высокие требования, то сопротивление базы представляется в виде последовательного соединения двух или больше сопротивлений, причем к точкам их соединения подключаются емкости запирающих слоев или их частей. Определение величин этих составляющих сопротивлений Гь проводится обычно эксперимеитальпо. Порядок величины сопротивления гь зависит от конструкции и типа транзистора и лежит между несколькими единицами Ома (мощные транзисторы, дрейфовые транзисторы) и несколькими сотнями OiM. Величина гь но своей природе (через Г/л) сильно зависит от рабочей точки и геометрии транзистора. Влияние геометрии можно легко учесть для относительно простых моделей, хотя при этом получается только компонент сопротивлення, не зависящий от эмиттерного тока. Для учета влияния распределения тока в базе требуется более точный анализ. Если, например, принять, что геометрия транзистора цилиндрическая (рис. 5.2) и радиусы эмиттера и коллектора равны, толщина базы постоянна и концентрация примеси независима от координаты в различном на-правлеини, то слон базы можно рассматривать как бесконечно тонкую шайбу с поверхностной проводимостью, равной  9 Jx/V(x) dx. (5.2) о С учетом этой проводилюсти можно рассчитать компонент сопротивления Гь2 а (5.3) г Компонент гы приближенно можно рассчитать, если 160 Едиоложйть, чго ток базы равномерно распределен по площади эмиттера и коллектора. В этом случае с током базы, рассматриваемым на расстоянии радиуса г{/в(г)], связано радиально направленное электрическое поле Е 27txV (5.4) После интегрирования этого соотношения и усреднения можно определить сопротивление 1 (5.5) Интересно отметить, что размер эмиттера не входит в это выражение. Приведем оценки рассмотренных величин у/, гы и г 1,2 для транзистора с равномерным распределением примеси в базе. В этом случае уравнение (5.2) принимает внд (5.6) откуда при W=\0 мкм, /Vp-lO см- [x =3800 см/В с получаем х'-0.61 Ш-з Ом-*-см-*; rbi = QS Ом, /-/,2=130 Ом (для \пга1г,= 0,5), Величина проводимости у/ для транзисторов с неравпомер-иым распределением примеси в базе теоретически почти иа порядок меньше, чем у/ для транзисторов с гомогешюн базой при прочих равных условиях. Сопротивление базы можно уменьшить за счет ее более сильного легирования, увеличения ширины, а также уменьшения расстояния от эмиттера до базового вывода. С этой точки зрения конструкция транзистора с круговым базовым электродом предпочтительнее конструкции с электродом базы, сосредоточенным в одном месте (см. гл. 7), Транзисторы с неравномерным распределением примеси имеют вблизи эмиттера высокую концентрацию примесных атомов (Л^г) IOiqis слг^), что является причиной падения у эмиттера подвижности носителей заряда и связанного с этим повышения сопротивления базы. Компонент сопротивления базы гы сильно зависит, кроме того, от плотности тока эмиттера, и при повышении плотности тока у краев эмиттера величина Гы несколько уменьшается (см. гл. 6). Предположения о постоянстве толщины базы и о равенстве площадей эмиттера Ае и коллектора Ас практически не выполняются. Для учета действительных условий сопротивление гь2 представляется в виде суммы щ нескольких компонентов (лри этом снимается предположение о paBefHCTBe и Лс), а гьи в свою очередь, представляется в виде нескольких слагаемых ((при этом снимается предположение о постоянстве толщины базы). Стремление получить большую иоверхностную проводимость yf за счет увеличения толщины базы и повышения концентрации примесных атомов вступает в противоречие с требованием достижения высоких предельных рабочих частот транзистора (fi 1/1, см. гл. 3). Повышение же концентрации примесных атомов в базе также ограничено верхним пределом, поскольку для получения хорошей эффективности эмиттера концентрация примеси в базе должна быть хотя бы на два порядка меньше концентрации примеси в эмиттере. Предельная же концентрация атомов примеси в эмиттере лежит между 10* и 10 см . С другой стороны, частотные свойства транзистора ухудпдаются из-за того, что с ростом концентрации примесных атомов увеличиваются зарядные емкости. Кроме того, при этом резко умепьнклются пробивные напряжения переходов, что ограничивает возможности применения транзистора в различных схемах. С точки зрения электрических характеристик сопротивление базы можно рассматривать: - как элемент, иа котором падает часть внешнего напряжения, что приводит к ослаблению эффекта усиления транзистора; - как элемент обратной связи по напряжению н мощности; - как вторичный элемент, ограничивающий частотный предел. Вследствие наличия диффузиониой емКости-эмиттера уменьшается напряжение Uri,., управляющее процессами во <свпутренпем транзисторе в связи с сопротиБле-нием базы, что является вторичной причиной ухудшения частотных свойств транзистора (см. гл. 12). При работе транзистора в режиме усиления следует принимать во внимание возможность возникновения нестабильности. >- Распределение напряжения между переходами и сопротивлениями приводит к ослаблению экспоненциальных зависимостей, описываемых урашепиями для постоянного тока [уравнение (2.11)], поскольку теперь вместо напряжений на переходах Ueb Ub следует под-  Ставлять напряжений (Vb +V) (5.7) Падением напряжения I/q + eee активном режиме Па пренебрегать нельзя. Падение напряжения на коллекторном переходе U,, практически не меняется, так как и ,q\Ui:,q,. При учете падений напряжений на последовательных сопротивлениях возникают дополнительные трудности в изображении вольтамперных характеристик транзистора, поскольку и без того нелинейные зависимости Ig = gpe,- lcb) iciUpjun Ucb) следует представить в форме ёЛев св) cfeb св) На практике эти трудности можно обойти, если сами токи /я, /с и 1в отнести к рабочей точке. Эта точка характеризуется чаще всего коллекторными напряжениями (UcB, Псе) и токами (/в, /с). Проще выглядят соотношения для линейно зависимых переменных токов и напряжений, так как между напряжениями на внешних клеммах и внутренних элементах транзистора существует простая связь (см. гл. 10). Модуляция сопротивления базы. В эквивалентной схеме замещения (рис. 5.1) учтено, что модуляция ширины запирающего слоя коллектора приводит к модуляции сопротивления базы по постоянному току гв\.- Из-за того, что с изменением напряжения граница базы у коллектора дышит , изменяется ширина базы W=Wq±A\V и, следовательно, изменяется гв{{). в в д\г==э с'в с'в (5.8) Протекание постоянного тока базы 1в по сопротивлению rB\{i) приводит к появлению дополнительного переменного напряжения w=q dU с'в с'в (5.9) На эквивалентной схеме замещения генератор напряжения }х^Д(/,, должен быть включен последовательнв И* т С сопротивлением r{W) и располагаться ближе к внутреннему транзистору, чем гщ. Так как эффект обратной связи по напряжению сигнала и по мощности, связанный с сопротивлением Гв1(0, обычно слабо выражен по сравнению с эффектом обратной связи, связанным с напряжением /ьГв1, то обычно модуляцией сопротивления базы пренебрегают.  ВЛИЯНИЕ НЕКОТОРЫХ СПЕЦИФИЧЕСКИХ ЭФФЕКТОВ НА СВОЙСТВА ТРАНЗИСТОРА Приведенное выше рассмотрение свойств транзистора проводилось при идеализации структуры транзистора, принципа его действия и основных соотношений, описы'вающих процесс управления явлениями в транзисторе. В конечном счете эти идеализированные предположения сводятся к так называемым условиям Шокли. В реальных практических структурах транзисторов в различных режимах работы возникает ряд явлений, связанных с отступлением от условий Шокли. Эти явления часто объясняются недостаточно четко, как это уже было показано на примере р-п перехода. Особенно трудно дать для реального транзистора детальную количественную картину процессов. Изложение этих вопросов выходит за рамки настоящей книги, и поэтому специфические эффекты рассматриваются качественно. Все отклонения от идеализированной модели можно разделить на отклонения, связанные с особенностями модели транзистора, и отклонения, связанные с переходом транзистора в различные критические режимы работы (табл. &Л). Что касается модели, то желательно, а для некоторых конструкций транзисторов необходимо (см. гл. 7) учитьквать поверхностную рекомбинацию и связанный с ней пространственный характер движения носителей заряда, играющий важную роль для многих электрических характеристик транзистора. Поэтому это явление должно рассматриваться не как отдельное, а как общее свойство транзистора. Далее, для кремниевых транзисторов, в отличие от германиевых, генерация и рекомбинация носителей в запирающем слое играют серьезную роль в некоторых режимах работы. Предельно допустимые параметры совре- Таблица 6.1. ВАЖНЕЙШИЕ СПЕЦИФИЧЕСКИЕ ФИЗИЧЕСКИЕ ЭФФЕКТЫ, ЮЗНИКАЮЩИЕ В ТРАНЗИСТОРАХ В РЕЖИМЕ НОРМАЛЬНЫХ И ПРЕДЕЛЬНЫХ НАГРУЗОК*) Особенности модели транзистора Особенности, связанные с режимом работы транзистора
Поверхностные эффекты (6-1); пространственный характер движения носнтелей заряда (многомерная модель транзистора с распределенными параметрами) Генерация и рекомбина-ция носителей заряда в запирающем слое (6.2) Нелинейные искажения К Модуляция сопротивления базы (6.3) - изменения малосигнальных параметров, частично индуктивные свой-ства; - умепь[[10иис эф;ек-тнвности эл1И7те};а и коэффициента перен(х:а, влияние тока на коэффициент передачи а (*.5.3); - влияние 1ффекта размноженим носнтелей - уменьигеиие времени жн:ши и шедвнжности неосновных носнтелей; - ослабление влияния встроенного электрического ноля в базе (6-3)- Комбинация эффектов, представленных в 1А и 15, а также частично в II и III к Падение напряжения на сопротивлении базы; - оттеснение тска к краю эмиттера (6,4); - участок отрицатель-ного сопротивления на вольтамперных характеристиках в области пробоя; - уменьшение напря-жения, фактически дейст-ствующего на переходах связь входной и выходной цепи прн передаче сигнала, 2. Г1<:1денне напряжения на последовательном со- п;[;Т11влен1Ш коллектора I, Модуляция ширины запирающего слоя (эффект Ирли); На пряжение прокола (6-5). 2- Размножение носителей в запирающем слое, обусловленное сильным электрическим полем (6.6) (первичный пробой). 3- Зинеровский пробой, 4- Эффект шнурования тока (вторичный пробой) (9,3) (пннч-эффект) К Превышение мак* снмальной температуры запирающего слоя. 2. Тепловые эффекты в различных режимах работы; - статический ре-, жим; поле вольтамперных характеристику - динамический режим: изменение усилительных свойств; - связь между температурой запирающего слоя и временной* функцией электрической мощности (нензо-термический эффект); л г - -J- j г Продолжение niadAi Щ Особенности ( свяганчые с режимом работы транзистора i. Инжекционные явления Особенности модели транзистора А. Низкий уровень инжекции большой сигнал Б. Высокий уровень инжекции (Р„ малый сигнал ФеЬ' т^ В. Высокий уровень инжекции, большой сигнал (выходной усилитель, ключевой режим) II. Нагрузка током Заметные падения напрЯ' жений в нейтральных областях (часто в комбИ' нации с 1Б) III. Предельные напряжения IV. Нагрузка мощностью  Ограничение допустимых напряжений, эффекты размножения Высокие мощности потерь, существенные тепловые нагрузки 2. Влияние последовательных сопротивлений и областей пространственного заряда иа свойства высокочастотных транзисторов; - снижение пробивного напряжения из-за ограничения скорости движения носнтелей заряда; - ухудшение ключевых свойств транзистора; - обратная инжекция в коллекторе (тирнстор-ный эффект); - снижение граничной частоты в меза-транзисто-рах из-за ограничения скорости движения носителей заряда (6.6). в некоторых дрейфовых и меза-транзнсторах: - увеличение остаточного напряжения на коллекторе; - эффект усиления в объеме коллектора (тепловая нестабильность) (6.6); - модификации структуры запирающего слоя коллектора (о.8). - етутренняя термическая стабилнзацвя в связи со вторичным пробоем (9.3); - внешняя термическая стабализация. ) В скобках приведены цифры, обозначающие главы и параграфы, где данное явление рассматривается подробно,  6 й&берХкостной рекомбинацией. СоответстбейНб этбМУ требуется внести коррекцию в вььражения как статических (An, Ai) [ура(внения (2.16)], так и динамических коэффициентов передачи тока (аь и аы) [уравнение (3.8)], причем с практической точки зрения поправки важны главным образом для коэффициента переноса   Линии тока Рис. 6.1, Линии тока неосноштых носителей геометрически несимметричной (а) и геометрически симметричной (б) транзисторной структуры. в случае б) потери, связанные с поиерхностноО рекомбинацией, больп]е, но они одинаковы для нормального и инверсного включения транзистора. носителей через базу транзистора, работающего в активном нормальном режиме на низких частотах (со-0) *>: А (6.1) Компонент тока базы /до (этот ток диффузионный) можно приближенно рассчитать с помощью задаваемой скорости поверхиостной рекомбинации s и избыточной концентрации неосновных иосптелей Ар = р-ро иепосредст-веино у поверхности [см. уравнение (1.78)]: qs Ар (х) dA, А (6.2) Строго говоря, при Бычислении этого интеграла следует рассматривать многомерную модель транзистора, однако возникающие трудности с вычислениями не всегда позволяют довести решение задачи до конца в явном виде. Поэтому для оценки рекомбинационных потерь Соответствующие уравнения для динамических процессов опускаются. В базе целесообразнее пользоваться моделями-аналогами. Эмиттерный ток дырок также зависит от распределения концентрации дырок по плоскости эмиттера й вычисляется по формуле (6.3) С помощью соотношений (6.2) и (6.3) можно просто рассчитать отношение Ibo/Iep для двух транзисторных структур, изображенных на рис. 6.2: 4Ws . ~jd; (6.4) Обратим внимание иа то, что для таких упрощенных моделей получаются отношения токов (6.4), которые не зависят от концентрации неосновных носителей заряда. Для уменьшения потерь на поверхностную рекомбинацию следует выбирать малую толщину базы п большую площадь эмиттера, а также с помощью специальной обработки поверхности (табл. 1.1) обес-  Рис. 0.2, Различные геометрические мололи транзисторных структур, пспол|,зуемые для оценки влияния поверхностной рекомбинации. печивать малую величину скорости поверхностной рекомбинации. В реальных транзисторах трудно отделить потери на поверхностную рекомбинацию от потерь на объемную рекомбинацию. Поэтому практически удобнее характеризовать рекомбинацию на поверхности поверхностным временем жизни [уравнение (1.79)], а уравнение для ко- --- - - -- эффициента переноса сохранить в первоначальном виде, формально введя в него эффективное время жизни: Во м'ногих транзисторах ттоверхностное время ж'изни существенно меньше объемного, так что базовый ток практически состоит только из тока, связанного с поверхностной рвком|бина1;ией, и по этой причине исключительно сильно зависит от свойств поверхности, которые, в свою очередь, определяются многоч1тсленны1ми факторами, связаннымИ с технологией изготовления. Поэтому может оказаться, что, хотя транзисторы имеют примерно равные толщины базы, их электрические характеристики могут иметь большой разброс. Для количественных сравнительных оценок долей объемной и поверхностной рекомбинаций воспользуемся следующими данными: W=40 мкм, 5=400 см/с, г = = 0,5iMM, Dp = 44 cmVc, Lp = 03 мм. Путем расчета получаем  8,95.10 ~7d7 6.Ю-. Заметим также, что отношение /ср в-Ш (при учете только объемной рекомбинации) уменьшается до 67 при учете и поверхностной рекомбинации. Влияние поверхностной рекомбинации стараются уменьшить тем, что создают геометрически несимметричную структуру транзистора (площадь коллектора Ас больше площади эмиттера Ае) - Но при этом приходится считаться с сильным уменьшением' инверсного коэффициента переноса. Если же необходимо иметь структуру с одинаковыми характеристиками в нормальном и^в инверсном включении, то площади Ас и Ае должны быть равны. Таким образом, в зависимости от конкретных условий следует выбирать наиболее целесообразное отношение площадей AcIAe. Зависимость статического коэффициента передачи тока В^=А^[.{1-An) от отношения площадей Ас/Ае представлена на рис. 6.3, причем при расчете этой зависимости принималось, что s=5 10 см/с. Достаточно четко выраженный максимум этой кривой лежит вблизи 1Л  коордииал Ас}Аё% причем положение максимума слабо зависит от скорости рекомбинации. Так, при десятикратном уменьшении величины скорости поверхностной рекомбинации увеличивается до -ЮО, а положение максимума сдвигается до значения, примерно равного Лс/£==3. О
Встроенное поле 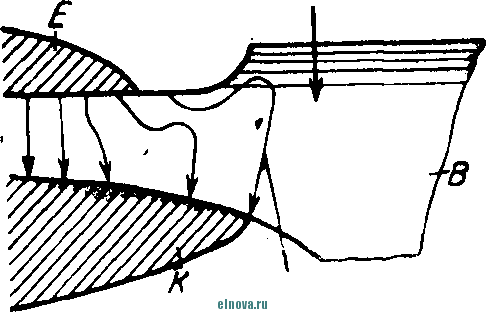 Рис. 6.3. Зависимость величины AnI(\-Ак) от отношения площадей Ас! А е. Скорость поверхностной рекомби-наинн принята равной -5000 см/с. Линии, тока неоснооных носителей Рис. 6.4. Влияние внутреннего встроенного электрического поля иа линии тока неосновн-ых носителей. Влияние поверхностной рекомбинации уменьшается. Более благоприятные услов^ия с точки зрения поверхностных явлений создаются в дрейфовом транзисторе, в котором благодаря наличию дрейфового поля в базе неосновные носители заряда в нормальном режиме отклоняются от поверхности базы со стороны эмиттера и направляются к коллектору (рис. 6.4). При инверсном же включении неосновные носители как в объеме базы, так и у поверхности движутся против поля, вследствие чего инверсный коэффициент переноса падает практически до нуля. Поверхностная рекомбинация оказывает влияние не только на коэффициенты переноса, но также и на токи насыщения транзистора, обусловливая появление дополнительных составляющих-токов насыщения. В эквивалентной схеме замещения наличие поверхностной рекомбинации может быть учтено с помощью включения дополнительных проводимостей. Эта проводимость со стороны эмиттера вычисляется по формуле 1 sA,W ё (6.6) 173 где Лв-част 08<й1 ШвМта^  инимаег участие в регкомбинаций (или эффективная ПJщaдь поверхностной рекомбинации). Поскольку в алстивном нормальном режиме диффузионная проводимость эмиттера шунтирует проводимость ger, ТО последняя не играет существенной роли. В то же время дополнительная проводимость gcr, вводимая в коллекторную цепь параллельно большому дифференциальному сопротивлению запертого коллекторного перехода, играет весьма важную роль. Эту проводимость называют остаточной проводимостью коллектора. Вообще говоря, она обусловлена не только влиянием поверхности, но также и рядом других причин. Таким образом, введение проводимости (6.7) позволяет учесть в совокупности все возможные факторы, определяющие появление зависимости тока /сво от напряжения. Крайне неприятное свойство, которое сопровождает поверхностные явления, связано с чувствительностью поверхностной рекомбинации к изменениям атмосферы, особенно к влажности среды. Изменения влажности могут происходить даже в герметически закрытом корпусе транзистора. Следствием этих изменений, связанных также с температурой, является нестабильность поверхностных свойств - особенно в течение длительного интервала времени,--а следовательно, и дрейф во времени электрических свойств транзистора. Состояние поверхности и ее свойства наиболее сильно подвержены влиянию кислорода и паров воды. В -конечном итоге состояние поверхности определяет величину и стабильность остаточных токов (например, /гво) и коэффициента передачи тока. Все меры, направленные на стабилизацию состояния поверхности, сводятся к тому, чтобы поддерживать в течение длительного времени внутри герметичной оболочки тот климат , который был первоначально там создан. Это достигается, например, заливкой транзисторной структуры компаундами или помещением ее в откачанный герметичный корпус (см. § 7.9). Однако исследования показали, что, хотя заливка структуры компаундом и затрудняет доступ парам воды к поверхности кристал-  Лй, но йОЛ^остью. вбс^п^эепятствовать toMy процессу ие может, так как с течением времени -в компаундовой оболочке образуются неустранимые микротрещины. Даже при помещении транзисториой структуры в откачанный герметичный корпус не удается полностью избавиться от мельчайших количеств паров воды, что приводит к окислению поверхности германия, падению коэффициента передачи тока и возрастанию остаточных токов уже непосредствено после герметизации прибора. Этот эффект, проявляющийся в первые дни (особенно в условиях повышенных температур) после изготовления транизстора, известен как 48-часовой эффект , так как только после этого времени выявляются относительно стабильные приборы. 48-часовой эффект связан как с необратимыми явлениями, обусловленными процессом окисления поверхности, так и с обратимыми явлениями, которые в первую очередь вызываются зависящей от температуры адсорбцией паров воды на иоверхиости полупроводника. Обратимые явления могут быть сведены к весьма слабо заметным путем длительного нагревания транзистора перед герметизацией, а также с помощью так называемых геттеров, или молекулярных сит, помещаемых внутри корпуса для поглощения влаги после герметизации. Наряду с изменениями параметров, выявляющимися в относительно короткий промежуток времени, существенное значение при применении транзисторов имеют изменения параметров, проявляющиеся в течение нескольких лет, так как они обычно иеиоратнмы н, как 1Н)авнло, ведут к ухудшению электрических cboiiCTH (увеличение обратных токов, уменьшение коэффициента передачи тока, уменьшение предельных запирающих напряжений на переходах). Эти измс-НС1ШЯ параметров связаны с процессом старсшш, что также накладывает ограннче1Н1е и а возможность npHMCiiciinvi транзистор оз. В таких случаях говорят о сроке службы:-> транзисгора и имеют прн этом в виду, что в течение определенного периода времени транзистор будет обладать определенными параметрами. Для транзистора трудно представить себе како11-либо очевидны!! ресурсный механизм старения, и поэтому иногда полагают, что его срок службы бесконечен. В действительности, однако, имеется ряд причин выхода его нз строя, которые связаны как с явлениями внутри кристаллической структур!,!, так и с явлениями на !10нсрх-иост!!-кристалла. Измс1!е!!ия внутри кристалл1!Чсско11 структуры происходят с относительно малой скоростью. В первую очередь речь идет о диффузии примесей, дефектов и т. д., о растворении германия в индии в твердой фазе (в сплавных транзисторах). На поБерхиости могут играть роль реакции с примесными атомами, с водоГ: и кислородом, а также изменения атомарной кристаллической структуры. Эти изменения становятся более замети!>1ми с увеличением температуры, а следовательно, и мощ1ГОСти, рассеиваемой транзистором. Таким образом, если к транзисторам предъявляется требование ста-биль110сти свойств в течение длительного периода времени, 01{И не должны подвергаться воздействию больших и длительных электрических нагрузок. Для защиты поверхности кроме компаунда может быть использован и окисный сло11. Так, например, поскольку окисел кремния очень стабилен, ои был применен как защитный слой в кремниевых транзисторах, обладающих значительной устойчивостью к внешним воздействиям (см. гл, 7). Окисный слон германия очень иеставилем, -] v ЧТО не позволяет использовать его для защиты поверхности. Однако предпринимаются попытки использовать окисиый сло^ кремния для защиты и германиевых приборов, что приводит к новым типам структур, обладающих относительной устойчивостью к внешним воздействиям. 6.2. Генерация и рекомбинация носителей заряда в запирающих слоях транзистора Как было показано в гл. I, для кремниевых полупроводниковых приборов предположение об отсутствии рекомбинации в'запирающем слое не всегда справедливо. Обычно нужно рассматривать ток через р-п переход состоящим из двух 1Компонентов: из компонента диффузионного тока Id и компонента рекомбинационного тока /д, определяемого соотношением (6.8) в принципе безразлично, рассматривается ли этот ре-комбииационный ток или (для случая приложения переменного сигнала малой амплитуды) дополнительная ре-комбинацноииая проводимость запирающего слоя: ехр и (6.9) где То - время жизни носителей волизи той плоскости р-п перехода, для которой pini. Ток рекомбинации в запирающем слое имеет важное значение при определении эффективности эмиттера кремниевых транзисторов, так как в эмиттериом переходе этих приборов может рекомбинировать значительная часть носителей заряда, попадающих в запирающий слой эмиттера. Если через /р.и 1еп обозначить диффузионные токи носителей, проходящих через запирающий слой, то эффективность эмиттера может быть представлена соотношением Т (6.10) При малых прямых смещениях рекомбинационный .компонент тока Ir превышает диффузионные токи 1ер и 1еп (тем более, что IepIeu, так как переход резко несимметричный) . Только при достижении более высоких плотностей токов рекомбинационный компонент тока  постепенно ановится сравнимым, а затем и пренебрежимо малым по сравнению с диффузионным (рис. 6.5). Относительно большая доля рекомбинационного тока в общем токе через эмиттер в кремниевых транзисторах объясняет тот факт, что в этих приборах коЭффициент передачи тока при прочих равных условиях в области малых эмиттерных токов меньше, чем -коэффициент передачи тока в германиевых транзисторах. Рис. 6.5. Зависимость статического коэффициента передачи тока Ллг кремниевого р-П'р транзистора от плотности тока эмиттера Se. О 10 W W 10 * SjA/cM Поскольку суммарный эмиттерный ток имеет как диффузионный, так и рекомбинационный компонент, но соотношение между ними заранее не известно, выражение для вольтамперной характеристики эмиттера записывается в общем виде: (6.11) иричед! эмпирическая пеличина коэффициента колеблется между значениями 1 и 2 и зависит от тока эмиттера. В коллекторно.м переходе, находящемся в запертом состоянии, возникаю!- процессы генерации носителей заряда, которые создают ток, увеличивающ11Й общий ток носителей заряда, генерируемых в нейтральных областях. Приведенные выше рассуждения опирались на представление о равномерном распределении рекомбинационных центров на поверхности, что позволяет сделать оценки только в первом приближении. Для современных конструкций транзисторов [как, например, для меза-транзисторов (см. § 7.6) и для планарных транзисторов (см. § 7.7)] эта оценка уже неудовлетворительна, так как в этих структурах вблизи поверхности имеет место скопление большого количества рекомбинационных центров. Наряду с ра1бсММрекШМй ctaTriqeckriMk ябленйймй генерация и рвком'бинация носителей заряда в запирающем слое могут 1при'вести к заметньш особенностям и при работе транзистора в динамическом режиме, и, прежде всего, в шумовых явлениях. 6.3. Высокий уровень инжекции Й'оследования, проведенные на полупроводниковых диодах, показали, что в противоположность представлениям, обоснованным в теории Шокли, при больших прямых токах в динамическом режиме р-п переход будет обладать не ем1Костной, а индуктивной проводимостью, что связано с модуляцией проводимости нейтральных областей перехода. В этих условиях концентрация инжектированных носителей заряда становится больше равновесной концентрации основных носителей, и в установлении электронейтральностй начинают играть роль дрейфовые токи неосновных носителей. В нейтральных областях в этом случае появляются такие электрические поля, которые не позволяют уже пренебрегать падением напряжения на последовательных сопротивлениях. По этой причине ;модель р-п перехода, использовавшаяся до сих пор, становится неприемлемой, поскольку она не соответствует процессам, связанным с новыми пробле-м а ми. Принципиально новый подход к анализу явлений в р-п переходе должен опЕфаться на решение полной системы уравне1!ий (1.1) с учетом также и электрического поля в нейтральных областях. Однако даже для одномсрно11 модели при злда1пшм законе распредслетш концентрации примеси и заданных граничных условиях решение этой системы для статического случая в элементарном виде получено быть пс может, а решение для динамического случая связано с большими трудностями. Поэтому в теоретических работах, касающихся режима работы р-п перехода при высоком уровне инжекции, обычно рассматривается модель, согласно которой вся структура опять-таки разбивается на область запирающего слоя и нейтральную область. Эти облас!н рассчитываются более или менее самостоятельно, причем для нейтральной области принимается выполненным условие квазинейтральности, т. е. допускается существование в этой области электрического поля, хотя и пренебрегается объемным зарядом в ней. Так, в одной из теорий для полностью симметричного р-п перехода (равенство концентраций примесей, подвижностей и диффузионных длин по обе стороны от р-п перехода) в предположении, что нейтральные области меньше диффузионных длин, получено выражение для вольтамперной характеристики р-п перехода при высоком уровне инжекццц в виде Л > Точный айиз практически применяемого резко несимметричного р-п перехода в статическом и динамическом режимах работы показывает, что его эквивалентная схема замещения для случая высокого уровня нижекции (рис. 6.6) существеиио отличается от схемы замещения для низкого уровня (рис. 1.12). Она содержит два последовательных сопротивления, ri и Гг, причем последнее Рис. 6.6. Эквивалентная схема замещения р-п перехода при высоком уровне инжекции.  Компонент последовательного' сопротивления Компоиент\ диффутон ного сопротивления зашунтировано индуктивностью /. Сопротивление fi примерно соответствует обычному последовательному сопротивлению, сопротивление же Гг н индуктивность / становятся заметными только ттри больших прямых токах. Более того, эти величины зависят от прямого тока. Напряжение, начиная с которого необходимо считаться с ин- п   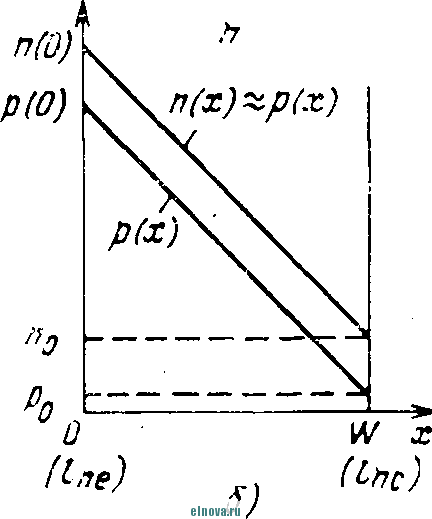 003 /г^-Л>=А> 03 £(х) О - Ц lin-< Ър Рис, 6.7. Распределение концентраций носителей заряда и токов в базовой области транзистора при низком (а) и высоком (б) уровнях инжекции. D ~~ диффузионный ток; f р - дрейфовый ток, 1 ... 5 6 7 8 9 10 11 ... 24 |
||||||||||||||||||||||||||||||||