
 | |
|
|
Главная » Книги и журналы 1 ... 4 5 6 7 8 9 10 ... 24 где   (4.106) фактор поля, имеющий значение для геп- - Ш. m = EWl2UT-мания 4, для кремния Величина при отсутствии поля (£ = 0) становится равной диффузионной длине, а распределение концентрации носителей соответствует случаю бездрейфового транзистора {pw = Po)- При наличии сильного поля в базе (E2Ut/Lp) величина Up становится не зависящей от диффузионной длины. Общее выражение (4.10а) для распределения концентрации неосновных иосптелей можно представить себе как сумму трех составляющих: а) концентрации, управляемой иапряжсн-ием на эмиттерном переходе: Рг (-) = Ра охр Е  L / j \ р / J (4.11а) б) концентрацпи, управляемой паиряжеииед[ на ко i лекториом переходе: А Н = Л схр т Е т (-v - Ine) (е' ~1)Х  (4.116) в) термодинамически равловесной копцентрацнн Pz () = Ро ехр Е (х 1пс) (4.11 в) Особый интерес представляет случай сильного поля, при котором объемной реколшинацией можно пренебречь (Lp-W/Lp-Ю). При этом выражение для распре-140 1-*, чу- - Й кощеитрации дырок приобретает простой внд (рис; 4.2): Р{Х) = [Роб (4.12) График pacпpeдeJfёния концентрации дырок в базе дрейфового транзистора показывает, что при большом электрическом поле падение концентрации дырок у эмиттера практически отсутствует, а у коллектора имеет ме- Рис. 4.2. Качественный ход графиков распределения концентрации неосновных носителей в базе дрейфового и бездрейфового транзисторов при условии слабой объемной рекомбинации. ЛрейфоВыа транзистор (Е'О) Бездрейфобый транзистор  сто резкий градиент концентрации дырок. Таким образом, вблизи эмиттера перенос носителей происходит преимущественно за счет дрейфа, а у коллектора - за счет диффузии. Диффузионный треугольник в этом случае вырождается в более сложную фигуру, которая приближенно может рассматриваться как трапеция, однако явление накопления заряда в базе сохраняет свой смысл. Общий заряд неосновных носителей в базе равен qA 1* р {х) dx о е^т 1 и и Е Е - 2т с (4.13) Это выражение позволяет ввести по аналогии с р-п переходом диффузионную емкость. При Е->-0, ф^\Ер< из уравнения (4.13) следует выражение для заряда в базе бездрейфового транзистора [уравнение (2.8)]. Для случая сильного поля (ml) при запертом коллекторе  *арад Q+ ргвет!даШ|Ш^ зна дл без дрейфового транзистора, у которого поддё'рживавтся то же самое значение ро: Q*qAp,Wt%p (4.14) В связи с введением понятия диффузионная емкость для дрейфового транзистора следует сделать пояснение, касающееся терминологии. Поскольку в базе дрейфового транзистора ток переносится преимущественно за счет дрейфа, то целесообразность введения термина диффузионная емкость вызывает сомнение. Поэтому появилось предложение называть эту емкость емкостью пространственного заряда неосновных носнтелей . Однако принятие такого термина внесло бы дополнительную путаницу, поскольку этим же термином обозначают емкость в максвелловском смысле, связанную с протеканием токов смещения через запирающий слой р-п перехода. Вот почему в дальнейшем сохраняется исходный термин диффузионная емкость . При расчете тока неосновных носителей в базе дрейфового транзистора следует учитывать-в общем случае как дрейфовую, так и диффузионную составляющую тока: Е dp \ dx > qADp {р .и qADp (р ( Г- dp \ (4.15) Уравнения переноса могут быть сами по себе использованы для расчета распределения концентрации неосновных носителей для транзистора, работающего в нормальном активном режиме, при любом законе распределения примеси и пренебрежении объемной рекомбинацией. Если подставить в уравнения (4.15) выражения для электрического поля [уравнение (4.6)], то после интегрирования получим AqDp Nr. (х) (4.16) Если учесть граничное условие p{W) из (4.16) получаем О, то С=0 и qADpN (x)\D N{x) dx (4.17)   (е 1) + / (е EBIT ЕсЛ^ \ OCBIT (4.18) где токи насьщения , qADpPo т qADpPo Up qADpPi W  Sh W/Up--CES (4.19a) (4.196;  (4.19b) Благодаря введению токов (4.19) получаются соотношения для статических характеристик, аналогичные соотношениям для бездрейфового транзистора. Для случая Е = = 0 (т = 0) те и другие выражения полностью совпадают. Выделение в токах пасыще1шя дрейфового {If) и диффузионного (Id) компонентов возможно в соответствии с уравнением переноса / dp\ I = qADp [jJP{)-aJ-h+D причем соответствующие компоненты тока связаны с компонентами распределения концентраций /?i(x), р2(х), так как термодинамически равновесная концентрация рз(х) не связана с протеканием тока: ESFp qADpp Е ESDp qADpP, 2С77 Т 1 W -cth и ECSF 0; / ECSD /c-znt-; cESF* CESD CSFp (4.20a) (4.205) qADpp CSDp qADpp \2й -cth (4.20b)  Ток насыщения емиттера состоит пренмущесшрнно из дрейфового тока, поскольку при больших полях диффузионным током Iesdp можно пренебречь. При приближении к коллектору соотношение между компонентами тока меняется. Если из эмиттера вытекает дрейфовый ток дырок . то коллектора достигает меньшее количество дырок. создающих диффузионный ток: 2m + (4.20r) -♦rt - + cth -jT Ash -jT w и exp W Б E w и и } (4.21) Поскольку у коллектора компонент концентрации дырок pi(x) становится равн])1М нулю, то равен пулю и дрейфовый компонент тока. Аналогичным образом выглядят соотношения, связанные с концентрацией р2(х), а именно: дрейфовая составляющая тока у коллектора меньше ди(5)фузио1шой. Поскольку дрейфовое поле у коллектора торхмозит дырки, инжектируемые коллектором в базу, то соответствующая концентрация дырок, управляемая коллекторным напряжением, резко падает, В результате появляется значительный Д1н1)фузионпьп 1 ток у коллектора Icsdp, во много раз превышающий диффузионный ток у эмиттера. Хотя дрейфовый .и диффу-зиоипын токи направлепы навстречу друг другу (уравпсние (4,19в)], т. е. Csp яЛОрр. Е и qADpP 2 т вблизи коллектора протекает ток, переносимый преимущественно за счет диффузии, причем больший, чем ток насыщения эмиттера Iesp, поскольку вблизи коллектора равновесная концентрация дырок больше, чем вблизи эмигтера. Ток насыщения 1ес& является диффузионным, -поскольку p2(x)\x = Q = 0. Другим следствием различия дырочных токоъ насы-нхения Iesp и Icsp является различие статических коэффициентов передачи тока А^ и Л/, несмотря на симметричную геометрию структуры: - -г - -II По сравнению, с бездрейфовым транзистором дрейфовый имеет более высокий коэффициент прямой передачи (так как чаиде всего т>1), в то время как инверсный коэффициент Аi вследствие наличия дрейфового поля суидественио меньше An- Если принять типичные значения т = 4, W/Lp = 0,l, то лолучим Л/=0,685 и An = = 0,9987, что объясняется наличием дрейфового поля в базе, направленного к коллектору. В реальном транзисторе различие между An и Ai становится енде более заметным из-за несимметричности структуры (Ас>Ае)у а также из-за возможности появления сильной поверхностной рекомбинации при инверсном включепин, так как дырки из коллектора должны двигаться против поля и поэтому с большей вероятностью устремляются к поверхности н там рекомбинируют. Подобные же соотношения справедливы и для транзисторов с базой, образованной в результате двойной диффузии. Следствием малых значений инверсного коэффициента Aj является то, что остаточные токи /сво и Iebq значительно меньше отличаются от соответствующих токов короткого замыкания. Электронные токи через р-п переходы в дрейфовом транзисторе, в котором концентрации акцепторов в эмиттере и в коллекторе не зависят от координаты, а площади эмиттера и коллектора равны, вычисляются подобно соответствующим токам бездрейфового транзистора 10-1323 145 ,й. - -  [уравйрнйе (ЛЗ)З; ift расчетах ог\т МзйШ- нуть трудности, связанные с тем, что для достижения высокой эффективности эмиттера требуется выполнить неравенство Л^лЕ>Л^0(/пе), поскольку* при достаточно сильно легированном коллекторе для получения существенного доля в (базе требуется высокое значение Мв(1пе), что, в свою очередь, ведет к увеличению Nae и уменьшает диффузионные длины. Статический коэффициент инжекции эмиттера ув дрейфового транзистора, или (1-Тя) П Esp DpLn {т+т cth т) {4.22a) определяется как отношение токов насыщения электронов и дырок. Эта величина при пренебрежении объемной рекомбинацией, а также при условии, что Мае не зависит от координаты, определяется фактором поля; для справедливо соотношение (1-Тя) PoDpLE (4.226) которое показывает, что ув не зависит от ширины базы. Трудность получения больших значений ув состоит в том, что из практических соображений не всегда удается достигнуть необходимого соотношения между Мп{1пе) и Nae (примерно 1 :50). Хотя из анализа статических характеристик дрейфового транзистора может создаться впечатление, что в этом отношении дрейфовый транзистор ничем существенным не отличается от бездрейфового, но на самом деле это не совсем так. В некоторых случаях имеются значительные различия, связанные с сильным легированием эмиттера и слабым легированием базы у коллектора (запирающие напряжения, эффект Ирли, зарядные емкости). Главное же преимущество дрейфового транзистора - дополнительное ускорение носителей заряда к коллектору- становится особенно заметным в динамических характеристиках транзистора. *) Разность (1-Y;) называется дефицитом инжекции. перев.  4J. диндми(1с1б4е CB при фшШбнии синусоидальнсиО сигнала Свойства дрейфового транзистора, связанные с приложением к переходам переменного сигнала малой амплитуды, описываются уравнением непрерывности так же, как и аналогичные свойства бездрейфового транзистора при учете зависимости концентрации неосновных носителей от времени. Отличие будет заключаться в том, что в уравнении для дрейфового транзистора появляется дополнительный член, пропорциональный электрическому полю. Из-за наличия дрейфового поля в базе для данного типа транзисторов твердо установлено направление В'Ключения, и его с полным основанием можно называть нормальным включением. При исследовании динамических свойств интерес представляют процессы в базовой области. Процессы, протекающие в нейтральных областях эмиттера и коллектора, интереса в данном случае не представляют, так как при условии независимости концентрации примеси в них от координаты они ие отличаются от аналогичных процессов в р-п переходе. Концентрации неосновных носителей и динамические характеристики при приложении к запирающим слоям синусоидальных сигналов. При условии независимости поля от координаты и при наличии синусоидального напряжения уравнение непрерывности для базовой области имеет внд 
dp Е dp dx Ut dx  (4.23) Решение этого уравнения при линеаризованных ных условиях гранич- Xlne, Р Цпе) = Ро V т и fCB \ с'Ь' и имеег вид Exl2Up sh и Р iUe) е V-ГзЬ^Лпс-Х  (4.24) По сравнению с бездрейфовым транзистором расдтре- деление р{х) в данном случае несколько отличается, а именно, так же, как и в статическом случае, при сильном поле нельзя выделить диффузионный треугольник . Наиболее существенное для динамических свойств различие находит свое отражение в формуле для комплексного аргумента:  Yo-\-m\ (4.25) Объемная рекомбинация [слагаемое {WILY] уже при относительно малых электрических полях не играет существенной роли, хотя с ростом поля (повышение степени легирования!) диффузионная длина несколько падает. В отношении частотных свойств следует заметить, что с ростом фактора поля частота f становится больше частоты fl, прежде чем аргумент станет существенно комплексным, т. е. прежде чем f станет больше нормировочной частоты дре11фового транзистора: / 1лр - / 1 ь (4.26) При максимальных значениях фактора поля ft;ip может в 8 раз превышать fi. Комплексные проводимости, связывающие переменные токи и напряжения, следуют из уравнения переноса п распределения козщентрацш ! неосновных носителей: пЛОрР, Г If сер - ( г 4- x cth х) ехр У т е'в> 777 т ехр (4.27а) (4.276) При это:1 были опущены пpoвoдиюcти усср и г/.с, связанные с коэффициентом ехр (f7,j,/f7y.), так как в нормальном активном режиме эти проводимости исчезающе малы. Замеьа 1\:ножителя exp{U,JUj) эмиттерным током 1, а также предположение, что IL <т, позволяет из точных выражений для проводи\юстей У т еер + И cth И А (е \ + XflCth Хо/ Y (4.28а) у л + о cth Xq) sh X получить приближенные:  2т  е (4.286) которые характеризуют внутренний транзистор. Проводимость Ie/Utj характеризующая рабочую точку, формально идентична (\/га)у хотя эмиттерный ток преимущественно переносится за счет дрейфа.  Рнс. 4.3. Годограф проводимости короткого замыкания эмиттера у сер, отнесенноГ! к квазнстатическому значению Усср (со-0). Фактор поля т=4 [для (oi см. урао-ненне (3.7)]. Рис. 4.4. Годограф проводимости npHMoii передачи f/ce, отнесен ион к квазнстатическому зиачсипю Усе (со-0). 0ст:.1Л1)НЬ!е параметры те же, что и Ни рис. 4,3. Частотные свойства обеих проводимостей сильно зависят от фактора поля и значительно слабее от (W/Lp), хотя по сравнению с бездрейфовым транзистором качественно новых результатов не получается. На рис. 4.3 показана частотная зависимость проводимости ко-:)Откого замыкания эмиттера уеер, причем фазовый угол гр=+45° соответствует частоте figpSfi. Следовательно, дрейфовое поле существенно повышает нормировочную частоту, однако при одинаковом со/со1др оно не ©носит  заметного улучшений характеристику, а скорей даже ухудшает, как это иЬказывает соответствующая зависимость для проводимости прямбй передачи (рис. 4.4). В то время как у бездрейфового транзистора модуль проводимости уменьшается в V2 раз по сравнению с низкочастотным значением только при частотах, когда <o/(oi?k3,8 [соответствующий фазовый угол ф==(-57**)], аналогичное соотношение для дрейфового транзистора наступает уже на гораздо более низких частотах. При отношении 0)/о)1=3,8 фазовый угол ф>(-90 *). Качественный ход графика частотной зависимости коэффициента переноса дрейфового транзистора в принципе подобен соответствующему графику для бездрейфового транзистора: п и ch и + 2 sh и Рп(-). Однако наличие дрейфового поля приводит к отличиям коэффициентов дрейфового транзистора от соответствующих коэффициентов бездрейфового. При наличии сильного дрейфового поля гиперболические функции могут быть заменены экспоненциальными, и тогда для случая низких частот (со->0) получается следующее выражение для коэффициента Ро:  2и о ехр т   ехр 2т (4.30) Отсюда видно, что коэффициент переноса ро несколько больше, чем у бездрейфового транзистора. Частотная за- висимость рп подробнее рассмотрена в гл. 12. Учет модуляции ширины запирающего слоя. В дрейфовом транзисторе модуляция ширины запирающих слоев также меняет положение границ базы Ine и /пс и тем самым концентрации неосновных носителей в базе. Качественное различие по сравнению с бездрейфовым состоит в том, что запирающий слой коллектора вследствие слабого легирования базы у коллектора проникает в базу гораздо глубже, а поэтому в расчетах следует принимать во внимание зависимость концентрации при- этому у кол*  меси ь базе Ot координаты, лектора меняется граничное условие: /(tCBnco) Р (псо) ЛСО  (4,31) и к распределению р{х) добавляется еи:е дополнительная величина [х) ---.-sn x sh x )х О (4,32) ЛСО ч С'в' Благодаря этому к проводимостям уес и Усср добавляются дополнительные проводимости уесг и ycczpt связывающие токи и напряжения: Е dp(x) \ qAD р, {X) rshx псО ПС О  и С'в qADp р, {X) Е f/j. dPz () \ (4.33) Е x cth x Р 2U ПС о и (4.34) Сравнение этих выражений с уравнением (4.27) показывает идентичность частотных зависимостей соответствующих проводимостей. Множитель пропорционален диффузионному то:ку коллектора, протекающему через коллекторный запирающий слой и отличающемуся от тока дырок, инжектированных из эмиттера. Если принять это во внимание, а также учесть ток основных носителей в определении эффективности эмиттера, то можно получить комшлекс- ISL- ные проводимасти у'и Уи Уг стора: yi = gd~ W + и Cth и в W + о cth Хо И у'о дрейфового транзи- m 4- Ио cth о (ш + XgCth Ио) sh и У'о - Уссгр {т + Хо cth Хо) sh X ГяАдР e2 (xcthx (4.35) (Хо cth Хо + т) Благодаря введению коэффициента др, связанного с напряжением 0,, и Уг + Х(, cth Х(, ср V . /и др- , - ii--j- X  с 2/п sh X о fee. (4.36) достигается то удобство, что и дрейфовый транзистор на эквивалентной схеме замещения может быть разделен иа пассивный и активный четырехполюспнк. При 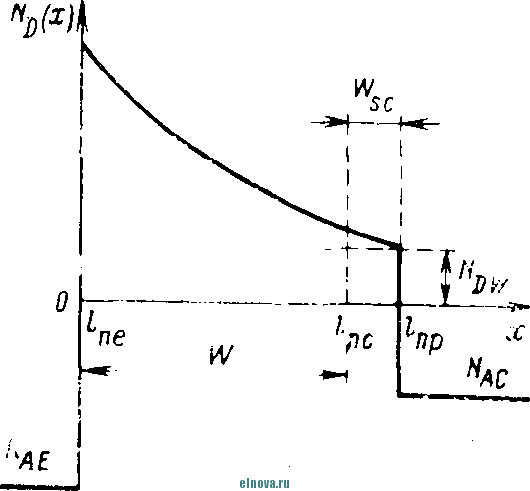 Рис, 4.5. Распределение коп-цеитрации примеси в областях дрейфового транзистора (к по. ясиеиию действия эффекта Ирли). одинаковых значениях коэффициент др при наличии дрейфового поля значительно меньше соответствующей величины при £ = 0, что во многих случаях ведет к упрощению расчетов вольтамперных динамических характеристик. Простая оценка коэффициента uIJuVqiq, при условии неоднородного распределения примеси в базе вытекает из следующих соображений. Из-за слабой легироваиности базы у коллектора запирающий слой коллектора распространяется преимущественно в базу. Правая граница запирающего слоя коллектора совпадает с геометрической границей резкого перехода от л- к р-области (рис, 4.5). При учете формулы, описывающей распределение примеси в базе, Г Е V(x) = iV)Ц7exp (/ р -X) (4.37) иитсгрироваинс уравнеиня Пуассона дает зависимость потенциала в запирающем слое коллектора б виде 2 г о ехр (/ Е и ехр (/ F Е /пс)+(х-/пс) ехр(/ р (4.38) Начало отсчета и данном случае совершенно произвольно выбрано при х = 1пг. Обн|,ес падение ианряжспня на з<нифаюи1,ем слое коллектор \Vsc = ln],-lni: lanuo ?(/np) f (nc) --Cli  и (4.39) Даже при запирающих слоях, меньших, чем толщина базы W, но при сильном дрейфовом поле в базе выполняется условие EVsc> > Ut Н при этом о Е Коэффициент
и qUrN Г' DW Uf,g,E (4.40) (4.41) имеет величину, меньшую, чем для р-п перехода бездрейфового транзистора с равномерным распределением примеси. Насколько эффект Ирли и связанные с ним внутренние параметры уг и г/о будут определять свойства внешнего транзистора, в значительной   Btepe збАиснт от rtsaa. Wita£ifiix элементов, как зврядные кости н последовательные сойрютнвления. На высоких частотах обеими проводимрстямн Уг, у\ Часто можио полиостью пренебречь. Во всяком случае, зарядные емкости следует принимать во внимание, особенно емкость эмиттера, поскольку оиа может иметь большие значения, так как обе области эмиттерного перехода сильно легированы. Преимущество дрейфового транзистора наиболее существенно проявляется только в динамических свойствах при работе на высоких частотах, в низкочастотном диапазоне свойства дрейфового и бездрейфового транзисторов почти не отличаются.  ВНЕШНИЙ ТРАНЗИСТОР. УЧЕТ НАЛИЧИЯ СОПРОТИВЛЕНИЯ БАЗЫ I-.- - . г,1- iJF Модельный транзистор отражает главные действующие эффекты, однако он является идеализацией реального транзистора. Характеристические параметры модели сравнительно слабо зависят от свойств полупроводникового материала, одномерная модель транзистора ие учитывает свойств конкретной геометрической структуры и, в частности, ие учитывает поверхностной рекомбинации. Во внешнем транзисторе, кроме этого, следует учесть движение основных носителей в нейтральных областях. Вследствие того, что проводимость этих областей н.меет конечную величину на них при протекании тока основных носителей возникает падение иапряжепия такой величины, что соответствующее электрическое ноле обеспечивает движение носителей заряда. Эти падения напряжения можно учесть, если ввести в рассмотрение последовательные сопротивления. Их величина зависит от геометрии и свойств материала, а также, вообще говоря, от частоты и от механизма возбуждения неравновесного состояния {ГеЕ, Гее и т. д.). Эти величины принято определять экспериментально и обычно подробно ие анализировать. Кроме того, поскольку точка (рис. 5.1) является весьма условной, то экспериментально определяемое сопротивление гь.ь зависит также от метода измерения, и поэтому для определения следует использовать метод, наиболее соответствующий условиям применёння прибора. Сосредоточенные элементы как для малосигнального режима работы /*,, /*с'с' статического ре- жима г^,, г^** и г^, включаются между ннешними * Ниже используются обозначения Гь вместо / / и Гв вместо Гд,д, если исключается возможность ошибочного понимания.  {£, 5, С) и внутренними {Е\ В\ С) клеммами транзистора (рис. 5.1). Эти элементы существенно видоизменяют электрические свойства внешнего транзистора в сравнении со свойствами внутреннего вследствие распределения внешнего напряжения между элементами структуры. Кроме того, иа высоких частотах иа распределение напряжения между элементами могут влиять паразитн1)1е  /а (дрейфЬВый) транзистор  Рис. 5.1. Припципиалыга^: с.хсмп замсчцспия i])airjiiCTOpa. Эта схема еключ.-к-т 1.,(ут1)оини1( транзистор (т, о, метьп-г.хио.-посипк- orpv жаю-;ип} процессы и е->:кос1И иростра]С1-и/ннцх за1 )идп[!, а таюк-ё гене- ратор \в'с'Ь\ умиыппошиГ: э.фект Ирлп, Схема <i4ieni;u.ro т1)аи.11!сто- 1>а ичл!о'1,-1ст. кроме того, пг.сл е.-овательпые cr,!i]iu i Н1Г1сипя. ни 4vkti]rhoci и lii.ino/ifi) а т.1КЖ0 1.01КЛ р\,т11Г'.11г,11 (.мкоети. элементы, такие, как конструктивные емкости между электродами (С,.? Ссь, Сгс) и иидуктивиости выводов (4, 4, /с). По существу, различие между внутренним и внен1-ним транзистором представляется в первую очередь чисто схемным. Исключением из этого до известной степени является сопротивление базы, так как в данном случае речь идет о распределенном сопротивлении. Выделение внутреннего транзистора из модели <овнешнего транзистора можно произвести достаточно просто в том случае, если такие элементы внешнего транзистора, как гь, Ccs, Ces, могут быть представлены 156 ка-к дискретные элементы. Для некоторых конструкций транзисторов (см. гл. 7) эти условия хорошо выполняются, для других же (оирсдслеииые типы плапарных транзисторов и меза-транзисторов)-хуже или вообще не выполняются. В таких случаях необходимо строить схему замещения с распределенными элементами. Насколько точно такие схемы замещения могут быть аппроксимированы с помощью простых схем, зависит от практических требований. Свойства внешнего транзистора прея;де всего определяются сопротивлением базы. Точный учет этого сопротивления и всевозможные преобразования схем замещения транзистора проводятся в рамках теории четырехполюсника (гл. 10). Следует заметить, что введением сопротивлении г^.с, Гсс и Гь пн в коем случае нельзя полностью учесть всех свойств внешнего транзистора (см. гл. 6). Влияние последовательных сопротивлений. Из трех последовательных сопротивлсниГ! транзистора сопротивле- ния г и г , явллютси иск )итическими, так как г iC С'С всегда, а г , чаш,е всего могут быть прелстаилены иа эквивалентной схеме замептснпя как диекрстпые :)лсмеп-ты. Их величина возрастает с ростом дл!П1Ы соответствующих областей и с уменьшением их ctchlmiii легирования. Во многих случаях (иапримс-р, п сплавных транзисторах) степень легирования эмиттера п коллектора настолько высока, что прн малых эмпти'рных токах сопротивления Гегс и Гс.с можно пс учитыва гь. В транзисторах, изготовленных методами диффузии, коллектор легирован слабо, чго заставляет учитывать сопротивление г^,. Значении г^ , и г^, колеблются от долей Ома в мопщых транзисторах до нескольких Ом (г^ ,) или нескольких десятков О.м (г^,) в .\ч!ломотцны.х транзисторах. Последовательное сопротивление коллектора определяется соотношением с с'с (5.1) Отсюда видно, что для уменьшения г^, следует выбирать как можно меньшее и как южнo большие и х^ Однако беспредельно увеличивать проводимость ней- 1 ... 4 5 6 7 8 9 10 ... 24 |