
 | |
|
|
Главная » Книги и журналы 1 ... 13 14 15 16 17 18 19 ... 24 {hnc или gi2c) сввдетельствует о более сильной обратной связи, IB то время как ft2ic и g2ic по модулю незначи- тельно отличаются от соответствующих параметров для схемы замещения с общим эмиттером. Эксплуатационные параметры. Влияние лараметров четырехполюсников на свойства схемы ,можно оценить, если проанализировать типичные значения этих параметров дл-я одного из типов бездрейфовых сплавных транзисторов (табл. 11.2).  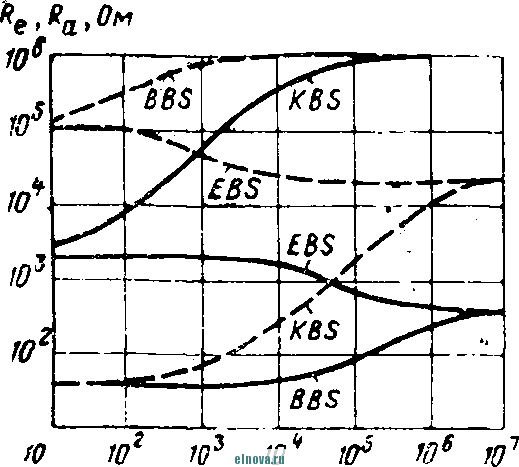 Рис. II.2. Зависимость входного Re (---) и выходного Ra (---) сопротивления от величины сопротивления на противоположной стороне че-гырехнолюсп1]Ка: -схема с общей базой; l-jis -- с\о\\а с обишм эмиттером; .\7is -с,\с\!а с общим коллектором. -С/ /?г Ом Входное сопротивление Z;=Rc (рис. 11.2) изменяется лод влиянием эффекта обратной связи [Н\г(Я.\2)\ в (Пределах между ha и Гц. Если рассматривать больиюй диапазон изменения сопротивления нагрузки/?т. (10 Ом 1 МОм), то можно считать, что значения сопротивлений, относящиеся (к левой части рис. 11.2, практически характеризуют режим короткого замыкания, а значения, относящиеся к правой части рисунка, характеризуют режим холостого хода. В промежуточных случаях сопротивление монотонно изменяется. Поскольку для схемы с общей базой и с общим коллектором величина /e2i>0, то Re возрастает с увеличением Rl (причем сильнее всего для схемы с общим коллектором), а в схеме с общим эмиттером Re падает (/i21<0). Соответственно этому Гнь = lle, а gile=gllc. Отношение входного сопротивления при холостом ходе к входному сопротивлеиию при коротком замыкании на выходе имеет наименьшую величину для схемы включения с общим эмиттером (например, для данных, приведенных в табл. 11.2,. оно равно 0,584). Наибольшую величину это отношение имеет для схемы с общим кол- Таблица 11.2 параметры Четырехполюсника для одного из типов германиевого бездрейфового транзистора (0С824) в различных схемах включения (-св = зв. = 0.5 мА, f = 1 кГц. Ьи = 25 с) 
лектором, что обусловлено тем, что коэффициент обратной связи по напряжению /zi2~l. /и (11.9) Отношение выходных сопротивлений при холостом ходе и коротком за,м1лкат1и на входе так^ке онрсде.1яет-ся уравнеинем (11.9) (общее cBoiicTBo четырех1К);1Юсни-ка). Соотвегственно этому выходное сопротивление Ra возрастает с ростом Rg в схемах с общей базо11 и с общим коллектором и надает и схеме с общим эмипером. Если учесть эквивалентное!ь некоторых сон])0гнв.те-пий для различных схем включения, nh)/Kho сд(.:ла1ь вы-вод, лто из-12 сонротивлеинн, относящихся к трем схемам включения, независимыми Morvi бьпь юлько 6 пз них, так как они связаны с иреде:1ьн1ЛМ!1 значеннями сопротивления нагрузки (О или оо). Эксплуатационный коэффициент передачи тока vi существенно зависит от сопро-гнвления нагрузки только в том случае, когда Gl сравнимо с (-/222), так как при этом выходной ток распределяется между (-/222) н Gl. Так как /i22e=/i22c, а -/г22ь<-/i22e, то уменьшение величины vi для схемы с общей базой начинает сказываться уже при относительно больших сопротивлениях. Зкоплуатационный коэффициент усиления но напряжению vu в схемах включения с общей базой и с общим коллектором положительный, в схеме с общим эмитте ром - отрицательный. По модулю он практически не отличается для схем с общей базой и с общим эмиттером. Само по себе очень большое значение коэффициента усиления по напряжению при холостом ходе на (выходе транзистора практически обычно не достигается, так как уже при условиях, близких к холостому ходу, сапротивление нагрузки должно составлять несколько единиц от (l/g22), ЧТО ведет (к трудностям осуществления такого режима, особенно для схемы с общей базой. cBS\ 
Рис. П.З. Зависимость номииальио-го коэффициента усиления по мощности Vpt от сопротивления нагрузки для всех трех схем включения. Режим работы - нормальный актив-11 ы Г|. 10 w 10 Ri. Ом Поминальный коэ(1)фп11,пепт усиления но ..мощности (рис. 11.3) прп согласовании, т. е. то1-да, когда входное и выходное сол1)Отпвлсиии выбраны в соответствии с условиями (10.32), всегда достпгаег своего макспму.ма. Вел еде гике очень вглсг^кого значения выходного сопротивления Б схеме с обп1,ен базой для псе соответствующее оитп.мальпое зпа^1еппе этого коэффпцнепта наибольшее, для схемы же с oonuiM коллекторох;, при относительно малом сопротиилепип нагрузки /i, - наименьшее. С точки зрения усилительных качеств схема с общим эмиттером счпгаеся иаплучшеп, так как для нее наблюдается большой коэффициент усиления как по напряжению, так и по току. Для схемы с общей базой также наблюдается значительный коэффициент усиления попа-пряжению, однако усиление по току в этой схеме отсутствует. Для схел1Ы же с общим коллектором наблюдается значительное усиление по току, однако из-за малого (практически равного единице) коэффициента усиления по напряжению усиление по мощности наименьшее. Максимум кривой зависимости Vpt{Rb), относящийся 1к этой схеме, существенно размыт и лежит при относительно Малом значении сопротивления паруки (Ю^ Oim), В области, лежащей левее максимума, кривые, относящиеся как к схеме с общим коллектором, так и к схеме с общей базой, расположены близко друг к другу. Если требуется получить большое усиление по мощности, предпочтительнее схема с общим эмиттером: к тому же входное и выходное сопротивления этой схемы имеют средние по величине значения п слабо зависят от 1внешпих сопротивлений на входе и -на пыходе, и, кроме того, отличаются по величине друг от друга значительно меньше, чем соответствующие соиротп1Влепия для схем с общей базой или с общим коллектором. При недостаточном согласовании в случае соединения каскадов Т^С-цепочками могут возникать потери мощности. Схема с общей базой рекомендуется тогда, когда необходимо иметь малое входное и высокое 1Выходное сопротивления, почти не зависящие от разброса параметров транзисторо'в. Однако многокаскадные усилители без согласующих трансформаторов, образованные на основе схем с общей базой, прн недостаточном согласовании работают при огпосительпо больших потерях мощности. В этом случае рекомендуется составлять многокаскадный усилитель на основе череду юи;ихся схем с общей базой и с обп1Пм эмиттером илн еще лучше с общим коллектором. Схема с общим коллекторо.м из-за ее малого коэффициента усиления по мощности практически пе применяется как усилитель, а чаще всего применяется как преобразователь импеданса. Благодаря высокому входному и малому выходному сопротивлению эта схема позволяет подключатьна входе еысокоо.М'Пый источник сигнала, а па выходе - низкоомпый приемник. Влияние температуры на параметры транзистора. Параметры четырехполюсни1ка, эквивалентного транзистору, связаны с сопротивлением базы, существешо зависящим от электропроводности полупроводника, а также с эксплуатационными параметрами-транзистора, зависящими от температуры. Вследствие наличия обеих этих связей наблюдается температурная зависимость характеристик транзистора. Из физических величин, определяющих температурную зависимость параметров транзисторов, следует прежде iBcero выделить следующие: электропроводность, связанную с подвижностью, которая уменьшается с увеличением температуры приблизительно oio закону (11.10) время жизни, которое три окружающей температуре ниже 25возрастает по зашну (11.11) выше этой температуры закон возрастания становится более медленным, а при температуре больше 50 С время жизни даже уменьшается; коэффициент диффузии, связанный с подвижностью соотношением Эйнштейна, который уменьшается с ростом температуры по закону (11.12) диффузионную длину, которая возрастает приблизительно по закону Lp-P. (11.13) Эти зависимости позволяют оценить общую температурную зависимость гибридных /г-параметров для схемы с общей базой: 1 и-г . а о и/  т 115. в (11.14) A2i6~const; -Л' Таким образом, для параметров hhib и /zi2b следует ожидать относительно сильную температурную зависимость, для h2ib она будет пе существенна, а для hhii, в широком диаатазоне изменения температуры наблюдается степенная зависимость с переменным показателем степени. С точки зрения практического применения в первую очередь представляет интерес температурная зависимость внешних параметров четырехполюсника, а также тенденции температурной зависимости элементов П-обраэной эквивалентной схемы замещения, особенно для схемы с общим эмиттером. Так, температурная зависимость проводимости в (11.15) определяется главным образом температурной зависимостью диффузионного сопротивления fd и .подвижности, так что следует ожидать общего уменьшения ge с ростом темшературы. В зависимости от того, нреобладает ли первое слагаемое в скобке уравнения (11.15), связанное с объемной рекомбинацией, или второе, связанное с эффективностью эмиттера, общая температурная зависимость проводимости ge имеет вид, представленный на рис. 11,4, и пропорциональна Т- или Г~. отн.ед. Рис. 11.4. Зависимость приведенных значений некоторых элементов П-образиой эквивалентной схемы замещения германиевого транзистора от температуры. и 6 В; / = 1 мА. с в С температура, к которой приведены все значения равна 25 С.  проводимость gc содержит, кроме составляющей, связанной с сопротивлением утечки, еще и диффузионную составляющую: Je \ f W W 2 (11.16) причем коэффициент \d\VldU,, \ yiiJv. для резкого р-п перехода вплоть до температуры 50X слабо зависит от температуры. Только при более высоких температурах начинается уменьшение gcdj закономерность которого определяется температурной зависимостью диффузионной длины. Проводимость , а. г dW gr <okugd (11.17) определяется в основном ширины запирающего слоя величиной ао и модуляцией и поэтому в широком тем- пературном штервале остается приблизительно постоянной величиной. Ход температурной зависимости внутренней крутизны в ociHOBHOiM определяется законом 1/7, как и следует из теории. Закономерности изменения приведенных параметров от температуры имеют некоторый разброс, однако в диапазоне температур 0-l50C (иногда и больше) ориентируются па следуюплие значения, характеризуюи;ие температурные изменения параметров германиевых сплавных транзисторов (ib %/°С): ТК [ЧоГС] -0,6 -0.5 +0,6 Сопротивление базы в области низких температур возрастает с ростом абсолютной температуры по закону Р, а затем при более высоких температурах вследствие наступления собствениой проводимости постепенно начинает уменьшаться. Максимум этой зависимости лежит выше температуры 30 С и, как правило, при температуре 50 С. С точки зрения применения важнее зпать ход температурной зависимости внешних параметров четырехполюсника (рис. 11.5). Приблизительно линейный характер зависимости Н^о может наблюдаться лишь в исключительно малом температурном интервале, вследствие влияния коэффициента усиления по току параметр h\\e растет по более быстрому закону, чем линейный. Отпосптельпо более быстрый закон изменения этого параметра для кремниевых транзисторов обусловливается влияйiieM рекомбинации внутри запирающего слоя, что учитывается фактором % в выражении для вольт-амперной характеристики (см. гл, 6). Коэффициент обратной связи по напряжению h\2c для германиевых транзисторов увеличивается как при низких, так и при высоких тем'пературах. Для кремниевых транзисторов при низких температурах обычно не наблюдается роста hi2c. Коэффициент усиления по току обычно возрастает, хотя и слабо, с ростом температуры во всем рабочем температурном интервале, причем для кремниевых транзисторов в тем1пературном интервале до 50 С слабее, чем для германиевых. Наконец, зависимость hzze(T) на- поминает зависимость hi2e{T), так как Htzc складывается из hi2e и добавочного члена Au5fo. Характер изменения Всех параметров с температурой зависит также й от положения рабочей точки, так что приводимые ib различных литературных источниках данные могут колебаться ;в широких пределах. Температурная зависимость внутренних г/гАьппараметров в основном определяется теми же самими закономерностями, что и Л-параметров. 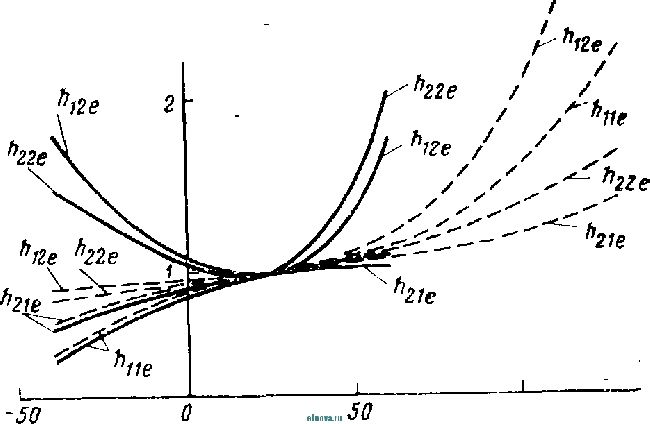 WO Ву°С Рис. 11.5. Температурная зависимость приведенных значений низкочастотных параметров hipe k=\,2), отнесенных к значению при Режим: -ОсЕ^ с = германиевый бездрей( )овый транзистор;---- - кремпиепый без- дрейфовый транзистор. Влияние положения рабочей точки. Квазпстатиче-ские малосигнальные параметры могут быть отнесены к величинам, которые существенно зависят от тока и напряжения. Для простых случаев применения достаточно знать зависимости гибридных параметров от тока амит-тера и напряжения на коллекторе -в том виде, в котором они нредставляются разработчиком прибора. Для детального рассмотрения зависимостей параметров от тока следует учесть более сложные явления, в том числе н связанные с высоким уровнем инжекции. Соответственно этому для he нельзя указать прямую связь между током (/) и напряжением (0,,), но можно ycTiibEHfb йейЁНую sBHcltMOCtb, йсйоЛьЗуй усЛоЁйв для грани'Ч'ной концентрации дырок /7(0): е'в dp{0) 4p(0)-/ p{0) AqDpM и t у1 и (11.18) Вследствие наличия функционального множителя ifi (рис. 11.6) при высоких токах к'ць(-*rd) падает медленнее, чем по закону 1 е. что всегда можно установить экспериментально (рис. 11.7). В конечном итоге можно определить, что диффузионное сопротивление возрастает от г^ до 2rd при больших токах. Ф1(1е) о.в 1Л 0.01 Рис. 11,6. Зависимость корректирующих коэффициентов -фь от фактора поля, характеризующего уровень инжекции Чо- Что касается положения фиктивной плоскости базы в' (гл. 6), то в данном случае следует учитывать соображения, изложс!!-ные на стр. 186, н тем самым -полностью учитывать падение напряжения в области базы. Если же рассматривать условия п. 1 и пренебрегать падением потенциала в базе, то при этом влияние высокого уровня инжекции на га уже ие учитывалось бы. В реальном транзисторе (и прежде всего в транзисторе с распределенным сопротивлением базы) наблюдается промежуточное значение диффузионного сопротивления между га и 2га. Особенность зависимостн от тока н\\ь не может быть объяснена только влиянием фактора г|)1 (/е), так как в выражение Л'иь входят еще гь и (1-ао), причем гь(Ie) является убывающей функцией. Более сложные соотношения наблюдаются для кремниевых приборов, поскольку в них важную роль именно при малых токах играет рекомбинация носителей заряда в запирающих слоях. На основании более точного расчета в этой случае следует вместо га пользоваться величиной г л (Si) (11.19) причем значение поправочного коэффициента % колеблется между 1 и 2 (рис. 11.8). При преобладающей рекомбинации значение X близко к 2, при преобладающей диффузии - близко к 1, но при высоком уровне инжекции вновь стремится к 2.  Рис. 11.7. Зависимость входного сопротивления hub от тока эмиттера. Различные кривые относятся к различным типам транзистора. Пунктиром показан график теоретической зависимости (без учета высокого уровня инжекции). Величина Л'иь цочти не зависит от напряжения на коллекторе, а вследствие возрастания а * и гь (из-за уменьшения толщины базы w) h\ib в конечном счете слабо умещшается. Часто экспериментально наблюдаемое последующее возрастание Л'иь прн больших напряжениях иа коллекторе не связано непосредственно с положением рабочей точки, а должно быть отнесено за счет влияния эффекта нагревания запирающего слоя (мощность потерь) и может быть использовано на .практике для измерения **). Токовая зависимость параметра Н'2\ь{==(1а) (или лучше (1-ао) определяется коэффициентом переноса ро и коэффициентом инжекции у^о. Тенденция этой зависимости сама по себе уже определяется зависимостью (1-Л^); отклонения этих двух зависимостей в коли- *) При малых токах эмиттера. **) Например, температту.ры. - Ярал . переводчика. чественном отношеннн незначительное. Зависимость коэффициента переноса ро от тока может быть достаточно точно описана прн учете поверхностной рекомбинации, если в соответствующем выражении коэффициент диффузии Dp заменить величиной D*p, зависящей от тока инжекции (см. гл. 6): (1--В с) - ( 2 (/я). (11.20) где Ф2 (fp) 1 + 2yj, D р Это соотпошенис основано иа предположении, что как объемная, так и поверхностная рекомбинация в первую очередь определяются грапичнон концентрацией дырок у эмиттера р{0). Вообще говоря,  Рнс. 11.8. 3aiMiCiiMocT{> коэффициента X от тока э^ПIттepa для TDCX кремниевых TpairnicTopoB тина ОС92 {-~UcB = 2B). 8 1,мА ЭТО предпо.и)Жсннс близко к денсгннто;н>ности в случаю нопсрхност-Р.01! реком\)Ннацн1(, но лля расчета обьсмной рскомбниа1и1И, строго 1-опоря, следовало бы нрнпнмать во внимание некую промежуточную концентранню между /;(0) и p{W) яь;0. Однако в качестве физического обоснопа!П1Я достаточно!! точности вышеприведенного условия может быть принято соображение, что объемная рекомбинация происходит преимущественно в области с высокой концентрацией ды-зок, т. е. вблизи эмиттера. Значение !Iioжитcля i 2 (рис. II.б) колеблется между I и 1/2 при больни1х плотностях тока, причем незав[1СИмо от положении фактических границ базы (х^ и .v-), т. е. можно считать, что возрастание ро объясняется причинамн, не завнсянщм!! от выбранной модели транзистора. Прн больших токах начиггает падать коэффицнепт пнжекцпн эмиттера. Довольно хорошим прибл]]жеипем для квазистатического случая является соотнон1-е (11.24) 1 д е U-pt - папряжепие прокола (см. гл. 6). Таким образом, 1-an уменьшается с ростом напряжения. Если же запирающий слои коллектора, наоборот, расширяется преимущественно в область коллектора (дрейфовые транзисторы), когда база имеет неоднородное распределение примеси,- то зависимость (1-an) = = 1{и^,,)\{с[блюле1ся лишь при малых напряжениях иа коллекторе, так как только сначала запирающий слой коллектора распространяется в область базы. Размножение носителей заряда ib коллекторе также может служить причиной зависимости ао от напряжения на коллекторе. Для коэффициента обратной свяда по налряжен'ию при' холостом ходе в эмиттере /ii2b можно получить вы-ражшне, -оправедливое при высоких плотностях тока: ш dp (0) dp (0) (11.25) SaEi-scHMOCTb этого параметра от напряжения в данном случае определяется фактором Ирли kc (см.гл.З) (уменьшаю щнмся с ростом напряжения), а зависимость от ока определяется фактором Ф1(/е) Обусловленное зтн[\: возрастание Л'зб с ростом /ic приводит также к за-Еискиости от тока коэффициента ku, который в ранних  0С82 \   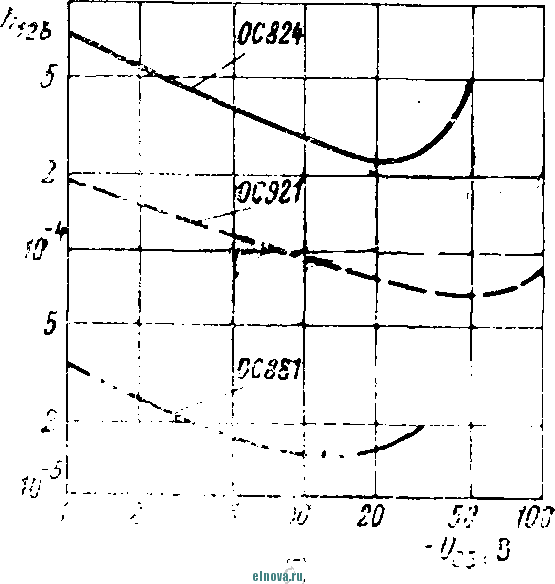 nr. il.j. >лiiv[п:;ocтf. коуффтшеигп обр:>т1Кл связи но напряжению ддя раз.И!чпых транзисторов: ; л тоьл .митIер-1 fl от иапряжония иа кол.ц-1 юре {/ ,. - 0,5 мЛ), 0;л2- - u ;iv 6e3,i; )cfiii5i;bil Tpiiic-iitcTfp; ОС881 ;-ерманиесый дрей- фа и; ы Г тр:1м;:1ч-1 ср (.млчения }ia миряд^и-; меньше); 0С921 - кремниевый беэ-.лрейфоиыЛ транзистор. теориях транзистора считался пе зависящим от /е. Таким образом, CTaHOBHTLH понятными зависимости hib от тока (рис. 11.9,а) и от напряжения (рис. 11.9,6). Заметим, что фактическая зависимость hi2h от тока и напряжения не так зна-чительна, как это следует из соотношения (11.25), поскольку расчет опирался на предположение о полном отсутствии падения напряжения в базе (стр. 272). Если же провести расчет, опираясь на первое условие (стр. 186), то окажется, что к\ь слабо 334 зависит от /jB- В реальном случае наблюдаются промежуточные закономерности. Дрейфовые транзисторы обладают слабой внутренней обратной связью и малым значением фактора Ирли. Наблюдающийся минимум зависимости fJizb {(-с'в') следует частично отнести за счет действия эффекта лавиннэго размножения, частично за счет термоэлектрических взаимодействии (см. гл. 17). Коэффициент обратной связи внешнего транзистора увеличивается по сравнению с hi2b внутреннего транзистора на величину (-Гьк'ггь), т. е.  (11.26) Зависимость выходной проводимости {-к'ггь) от рабочей точки определяется соотношением dct-o dW dU(.,Q, dW dU (11.27) Пели пренебречь остаточным током Icuo и полагать, что чо1е - 1с, то получим соотношение е (11.28) Что касается зависимости к'22ь от то при малых токах должна была бы наблюдаться прямая пропорциональность, хотя ф2(/:) действует в обратном направлении. Только при больших токах главную роль начинает играть последнее слагаемое, связанное с эффективностью эмиттера, и зависимость становится промежуточной между линейной и квадратичной (рис. 11.10,а). Зависимость от напряжения ftiab практически совпадает с зависимостью Л'ггь (С'в') поскольку она преимущественно определяется множителем {у^\ При более высоких напряжениях (лавин- ный пробой) может наблюдаться повторное возрастание /г',2Ь (рис. 11.9,(5 ). г С-опрогБЗл :Fe €а зы ве:ьчга слсжным образом зави-от положения рабочей тючки. 3 то время как ком-п:>нент .сапро11сзле*ння базы Гь2 отЕосителыно слабо зависит от TOiris л згадскт лишь от геометрии и (Материала э^зы, iLOMiicHeHT солротзвлелия базы гы существевно завискг от п рстек.а]ошгго 1сча. Лезшь при малых плот-н: Стях тока, когда икеет место более или менее равпомерпое распределенме гллотееости тока по сечению эмит-:ера, справедливо соэт]к ление tbilnW, которое -Л  22Ь  f h I 00891  5 W 20 50 ю0 5} Рис. 3J.:0. ani.viimoci, гихол.юи [1 )овол1гиостп !г22ь для разлпч)г1,1х tpaiisrctcpois: о] от -ck:i э^ч1 1 tj;.!, ;primtcrop сcs?4: cj i )t:i :j : - . .Г 1:: j j ;:г:.::г' ,{i > (/ r. - Li Г) мЛ ! . > - ур:азывает i:a лезпгигспмость r.,\ о: радиуса эмиттера. Прп 6ольи1и>: тсках комлопсеп солрогивлепия базы гы уменьшается, поско/1ьку - наступает эффект модуляции проводимости (сопротивления) материала базы; - настуиае? эффект отгеснс[1ия тока; этот эффект стапсвится особеи!ю заметным, если падение напряжения иа Гь\ достиггет величины порядка Ut. Что касается зависимости гъ от напряжения, то зследствие дейстз/.я эффекта Ирли в сплавных транзисторах -всегда -наблюдается рост Гь с ростом Ucb. Поскольку сопротиБлевие базы н значительной мере определяется способом изготовления транзистора и видом конструкции, равномерностью базового промежутка и свойствами полупроводника, а замена базовой обла- сти а эквивалентной схеме замещения оДйиМ сопротий-лением является лишь первым приближением, то имеются весьма различные зависимости гь от рабочей точки, в большинстве случаев, однако, овидетельствующие об уменьшении сопротивления базы с увеличением тока эмиттера. Кроме того, некоторое влияние на результаты измерений оказывает сам способ измерения. Так, например, при измерениях со стороны эмиттерной цепи получаются более низкие значения сопрогивления Гь, чем при из1мерениях со стороны коллекторной цепи: при измерениях в инверсном режиме также получаются несколько иные значения гь. Зависимость параметров четырехполюсников от рабочей точки относится н к внешним проводимостям gik. Поскольку соответствующие соотношения можно легко получить из выражений для внутренних параметров, то более подробно этот ibonpoc не рассматривается. Знание зависимости от режима параметров четырехполюсника для схемы с общей базой позволяет сделать заключение об аналогичных зависимостях параметров для схемы с общим эмиттером. Для параметра /iaie в зависимости от h наблюдается ярко выраженный ма1ксимум, что уже рассматривалось нами выше. Согласно этому анализу параметр /г'и^ при токах меньших, чем 1е{мйкс соответствующих максиму-\[у /г'2к-, падает с pocTONi тока слабее, чем по закону \/1еу а по другую сюропу от максимума /i2ie -сильнее, чем по закону \/1е. Параметр же Л'гге наоборот, перед максимумом возрастает сильнее, а после него слабее, чем h22b- В обоих случаях отличия закономерностей носят количественный характер, так что качественно ход зависимостей h\ie и Л'22е остается тем же самым, что и у соответствующих параметров для схемы с общей базой. Зависимость от иапряжепия на коллекторе параметров /г'ие и h22e определястся главным образом зависимостью параметра /i2ie, по крайней мере до тех пор, пока исключаются очень высокие напряжения на коллекторе. Зависимость h\2e от рабочей точки так же, ikbk и зависимость h\2by трудно представить в общем виде. Довольно часто в зависимости от Ucb наблюдается минимум, так как при высоких запирающих напряжениях начинается лавинное размножение носителей заряда. Эффекты умножения тока в коллекторе, рассмотрен- 22-1323 - 337
При этом  м (11.33) представляет собой лавинную проводимость (проводимость в области лавинного пробоя). В режиме усиления, когда М' только иа несколько долей процента превышает единицу, эффектом умножения можио всегда пренебречь, если М' входит непосредственно как коэффициент умножения, например, в случае внутренних -параметров четырехполюсника транзистора в схеме с общей базой, а также в случае параметра Лггь- В тех же случаях, когда в выражение для параметра четырехполюсника входит разность (М'-1), влияние эффекта умножения начинает сказываться уже при относительно малых напряжениях на коллекторе Ucb. В особенности это важно при условии, когда а^е{М'-\)>\. (11.34) В этом случае проводимости (например, г/ие и -Лгге) представляются величинами с отрицательной действительной частью. Изменяется знак у действительной части, меняется знак и у параметра Это связано с тем, что при напряжении -Ubrcfo эффицпент /l,v достигает значения 1, а при напряжениях - UcE> - Ubrceo возникают падающие входная и выходная характеристики. На практике этот эффект используется с целью генерации Колебаний в лавинных транзисторах, которые без введения доиолпительпоп обратной связи сами по себе н состоянии работать в качестве двухполюсника с падающей характеристикой. Напряжеине па коллекторе оказывает существенное влияние на низкочастотные параметры в тех случаях, когда Какой-либо параметр пеносредственио связан с лавинной проводимостью gav (ИаПрИМер, -/1226, hub, ~h22ey hl2e-> -i/22c) /722Т, Af (gad + .Selu + gcr + ai:)- /ii2b oku--rbM {ag,k-ga-{-Scr~ (11.35) -Sav)- с увеличением напряжения на коллекторе слагаемые, связанные с диффузионным процессом (gc, gcd), уменьшаются, в то время 1как М\ а также gav возрастают, так что наблюдается характерпый минимум на трафиках зависимостей 1ц2ъ, ~h22b = f{UcB) (см. рис. 11.9, 11.10). Подобные же зависимости можно устанонить также и для £/i2b- и г/22&параметров. ЧАСТОТНЫЕ ХАРАКТЕРИСТИКИ ЧЕТЫРЕХПОЛЮСНИКОВ Частотные свойства транзистора имеют большое значение при его нрименении, так как частотные явления, обусловленные медленным движением носителей за-:)яда, проявляются и должны учитываться уже при относительно низких частотах (иногда порядка нескольких килогерц). Удобное, наглядное представление о частотных янле-ппях дают эквивалентные схемы как формальные, так и такие, которые непосредственно передают информацию о физических процессах в транзисторе с помощью электротехнических аналогии (см. гл. 13). В основе характеристических параметров, избранных из практических соображении, н конечном счете лежат частотные свойства модели транзистора, дополненного впешпнмн схемными элементами. Как основу для определения параметров четырехполюсников можно также использовать сложные схемы замещения, построенные для реальных структур транзисторов, и затем путем ип-терпретацпп экоперпмеитальных параметров четырехполюсников определить элементы этих параметров, учитывая при этом метод измерения. Для точного проведения таких измерении и их обсуждения требуется знать основные частотные зависимости параметров модели транзистора (гл. 12) и построить целесообразную схему замещения (гл. 13), а также изучить влияние элементов схемы замещения на частотные, свойства (гл. 14). Не всегда (и, собственно, только в редких случаях) требуется точное представление о частотных функциях элементов схемы замещения. Наоборот, обычно даже стараются точные частотные функции модели транзистора заменить наиболее простыми приближениями и ~таким образом получить соотношения, которыми легко руководствоваться в 1практичеокой работе (гл. 14). ы: V ; частотные завнсншюсти некоторых внутренних пара* Метров четырехполюсников. Наряду с tBHyTpeKHnMH па- раметрами транзистора St, уг, г/оГурашение (3.26)] для схемы с общей базой имеют определенное значение параметры /г'21ь и А'ггь, а также у\\е^Уе, hziey hze и -у'\2е=Ус для схемы с общим эмиттером. Частотные характеристики этих (параметров для бездрейфового транзистора представлены в табл. 12.1. Таблица 12.1 ЧАСТОТНЫЕ ХАРАКТЕРИСТИКИ НЕКОТОРЫХ ПАРАМЕТРОВ БЕЗДРЕЙФОВОГО ТРАНЗИСТОРА Параметр Частотная характеристика у'и у'о h2xe Уе. У, 22е th а sh а ch а ch о - 1 sh о (I + ch а) а th а К2(1-р„)+ 2/<>; со (02 2Dp Для всех данных частотных зависимостей предполагается, что 7=1, т. е., электронным компонентом тока эмиттера пренебрегают. Условие ku<\ и без того выполняется. Ка-ких-либо особенностей в связи с предполо-  жением, что уеф\р следует ожидать лтпь для параметров hnb и Л'гае, которые сильнее всего связаны с уе. Для шрактичес^кого применения можно рекомендовать приближенные соотношения, получающиеся :в результате разложения в ряд гиперболических функций. Ниже приведен ряд таких соотношений, справедливых при условии а| <1, и, следовательно, /<Д: ctha 1 + (2V6) + (/22/3) 1 + (2V9) sh о 1 + ( 3) ch а 1 + (i -Po) + / shcj (l + cho) 2 + jQ/3. (12.1) atha 2(l ~pj + 2jQ; ch(3- l) = (3th ch tJ - 1 sh a 1 - + /2 3a исключением трех последних в (12.1) функций, определяющих ((/е, (/с, S, hz\e, /1225)-параметры, во всех остальных случаях с существенной частотной зависимостью следует считаться вблизи частот f /i. Для последних же трех функций с частотной зависимостью следует считаться уже па частотах порядка f(l-Mfi. (12.2) г, отн. ед. IB 0,6 ОЛ  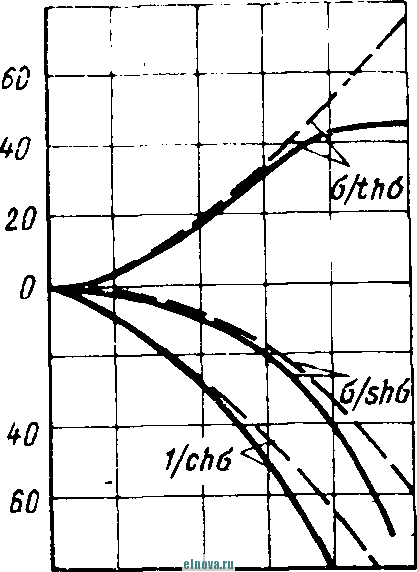 0,1 0,2 0,5 1 0.1 ОЛ 0,5 Г 2 5 Рис. 12.1. Частотные характеристики параметров внутреннего четырехполюсника бездрейфового транзистора: ----точный расчет;----приближенный расчет по уравнению (12.1). 1 ... 13 14 15 16 17 18 19 ... 24 |
||||||||||||||||||||||||||||||||||||||||||||||||||||||||